京都大學(xué)研究生院工學(xué)研究科的木本恒暢教授、東京工業(yè)大學(xué)科學(xué)技術(shù)創(chuàng)成研究院的松下雄一郎特任副教授及小林拓真博士研究員等人組成的研究團(tuán)隊(duì),把被視為節(jié)能王牌的SiC半導(dǎo)體20多年來面臨的主要問題——半導(dǎo)體缺陷降低了一位數(shù),成功地將性能提高了約10倍。
以Si為中心的半導(dǎo)體不僅是計(jì)算機(jī)邏輯和存儲(chǔ)器,還廣泛應(yīng)用于純電動(dòng)汽車、電車的馬達(dá)控制及電源等,但存在耗電量(功耗)較大的問題。近年來,為降低功耗,性能優(yōu)于Si的SiC晶體管的開發(fā)變得活躍,并開始實(shí)現(xiàn)實(shí)用化。
不過,20多年來,SiC晶體管的核心部位氧化膜與SiC的邊界部分(界面)始終存在很多缺陷,無法充分發(fā)揮SiC本來的特長。
本次研究將SiC功率半導(dǎo)體存在的最主要問題——氧化膜與SiC界面的特性提高了約10倍,有望一舉加速SiC功率半導(dǎo)體的實(shí)用化及由此產(chǎn)生的節(jié)能效果。此次提出的方法完全不需要使用特殊裝置或特殊氣體和化學(xué)物質(zhì),從事半導(dǎo)體器件業(yè)務(wù)的企業(yè)都可以無障礙地采用。還具備能擺脫一氧化氮?jiǎng)《練怏w的巨大優(yōu)點(diǎn)。
將此次的研究成果應(yīng)用于SiC晶體管(MOSFET)可獲得以下優(yōu)點(diǎn):
大幅提高晶體管的性能;
通過削減芯片面積大幅降低成本;
大幅提高可靠性。
尤其是優(yōu)點(diǎn)(2),降低成本,便可以大大加快在目前因?yàn)槌杀驹蚨q豫是否要采用SiC晶體管的系統(tǒng)上配備。全球的SiC功率半導(dǎo)體的市場規(guī)?,F(xiàn)在約為700億日元,預(yù)計(jì)5年后將超過2,000億日元。據(jù)估算,通過配備SiC功率半導(dǎo)體,有望節(jié)約相當(dāng)于數(shù)座核電站的能源。

形成超高品質(zhì)SiO2/SiC界面
研究方法與成果
Si半導(dǎo)體中最重要的晶體管是利用氧化膜與半導(dǎo)體的結(jié)的MOSFET(金屬-氧化膜半導(dǎo)體場效應(yīng)晶體管)。Si MOSFET幾乎在所有應(yīng)用中都是最重要和最基本的器件,比如計(jì)算機(jī)邏輯、存儲(chǔ)器、圖像傳感器以及電力用功率器件等。
Si MOSFET的核心部位就是氧化膜與Si的結(jié)界面。Si MOSFET利用了通過熱氧化Si(在氧氣氣氛中加熱至高溫)會(huì)在Si表面形成高質(zhì)量氧化膜(SiO2)的特點(diǎn)。
與Si一樣,熱氧化SiC也會(huì)在表面形成SiO2膜,這被視為SiC的一大優(yōu)點(diǎn)。以前一直利用這種方法形成氧化膜(SiO2膜)與SiC的結(jié),制作SiC晶體管(MOSFET)。不過觀察發(fā)現(xiàn),氧化膜/SiC的結(jié)界面存在非常多的缺陷(Si的100倍以上),這種界面缺陷大大限制了SiC晶體管的性能。業(yè)界一直嘗試通過調(diào)整SiC的氧化條件,或熱氧化后在各種條件下進(jìn)行熱處理來降低氧化膜與SiC界面的缺陷,但20多年來始終沒有取得明顯的進(jìn)展。另外,也一直不清楚氧化膜與SiC的界面缺陷的形成原因,始終不知道該如何提高品質(zhì)。
此次,松下特任副教授等人的研究團(tuán)隊(duì)利用第一性原理計(jì)算發(fā)現(xiàn),熱氧化SiC時(shí)肯定會(huì)在界面高密度形成由碳原子引起的缺陷。木本教授等人根據(jù)該計(jì)算結(jié)果朝著乍一看很矛盾的目標(biāo)推進(jìn)了實(shí)驗(yàn)研究,即“在不氧化SiC的情況下形成優(yōu)質(zhì)氧化膜=通過一層也不氧化SiC的方法形成優(yōu)質(zhì)氧化膜”。研究團(tuán)隊(duì)根據(jù)理論反復(fù)進(jìn)行思考和實(shí)驗(yàn),發(fā)現(xiàn)以下兩點(diǎn)能有效減少缺陷。
構(gòu)思了在干凈的SiC表面堆積Si薄膜,通過對其進(jìn)行低溫氧化,將Si薄膜轉(zhuǎn)化為SiO2膜的想法,并利用該方法成功形成了高品質(zhì)SiO2膜。Si的氧化起始溫度約為700℃,SiC的氧化起始溫度約為900℃,因此,在二者中間選擇合適溫度的話,完全無需氧化SiC,就能將Si薄膜徹底轉(zhuǎn)化為SiO2膜。
利用上述方法在SiC表面形成SiO2膜后,通過向界面導(dǎo)入氮原子提高了品質(zhì)。一直以來,通過基于一氧化氮(NO)氣體的界面氮化來提高品質(zhì)的方法還被廣泛應(yīng)用于SiC MOSFET的量產(chǎn),但使用NO氣體的話,在向界面導(dǎo)入氮原子的同時(shí),NO氣體分子中的氧原子還會(huì)促進(jìn)SiC氧化,從而生成新的缺陷。另外,NO氣體為劇毒氣體,因此應(yīng)該避免在量產(chǎn)工廠使用。此次,木本教授等人通過在高溫氮?dú)猓∟2)氣氛中進(jìn)行熱處理,成功得到了高品質(zhì)界面。
圖1展示了常規(guī)的全球標(biāo)準(zhǔn)方法“熱氧化→一氧化氮(NO)氣體處理”和此次研究(“Si堆積→通過Si低溫氧化形成SiO2膜→在高溫下氮?dú)馔嘶?rdquo;)的方法。圖2比較了分別用這兩種方法形成的SiO2/SiC界面缺陷。如圖所示,與常規(guī)的全球標(biāo)準(zhǔn)方法(目前的最好方法)相比,性能提高了10倍(缺陷量1/10)。具體來說,利用自主開發(fā)的方法,將常規(guī)方法中存在的1.3x1011cm-2的缺陷密度成功降到了1.2x1010cm-2。另外,此次研究實(shí)施了很多系統(tǒng)性的的實(shí)驗(yàn),確認(rèn)只要SiC半導(dǎo)體表面有輕微的氧化,就無法形成這種超高品質(zhì)的界面。
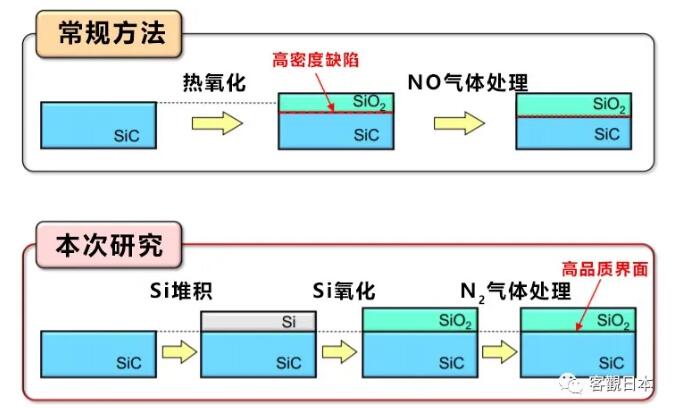
圖1:形成SiO2/SiC結(jié)構(gòu)的方法模式圖(上:常規(guī)方法,下:此次研究提出的方法)
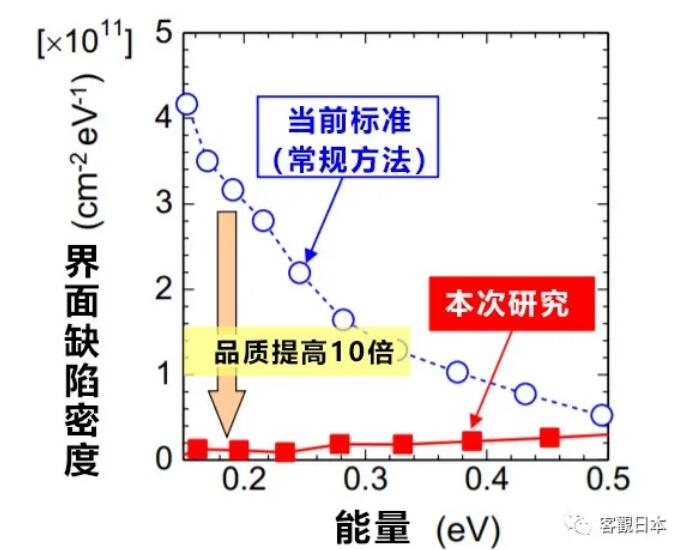
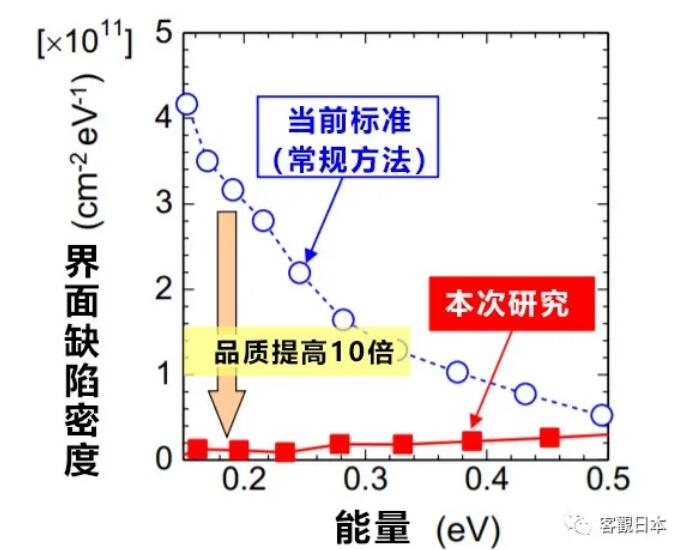
圖2:降低SiO2/SiC界面缺陷的實(shí)驗(yàn)數(shù)據(jù)
“氧化SiC在表面形成SiO2膜,將其用于SiC晶體管”——此次打破了這種一直以來的認(rèn)識(shí),通過“在不氧化SiC的情況下在表面形成優(yōu)質(zhì)氧化膜”的“逆向思維”,解決了困擾該領(lǐng)域20多年的技術(shù)課題,實(shí)現(xiàn)了重大突破。
【論文信息】
題目:Design and formation ofSiC(0001)/SiO2 interfaces via Sideposition followed by low-temperatureoxidation and high-temperature nitridation
期刊:Applied Physics Express
DOI:10.35848/1882-0786/ababed
