知名分析機(jī)構(gòu)Yole Developpement 表示,與 2019 年相比,頂級 OSAT(外包半導(dǎo)體組裝和測試)的收入在 2020 年增長了 15-20%,預(yù)計 2021 年將成為 OSAT 的“旗幟年”。
他們進(jìn)一步表示,2020 年至 2026 年,先進(jìn)封裝收入預(yù)計將以 7.9% 的復(fù)合年增長率增長。
報告顯示,到2026 年,F(xiàn)CCSP(倒裝芯片芯片規(guī)模封裝)細(xì)分市場將達(dá)到 100 億美元以上。這些封裝解決方案主要用于基帶、射頻收發(fā)器、存儲器和一些 PMIC 應(yīng)用。
FCCSP封裝市場份額主要由日月光、Amkor、JCET等頂級OSAT和三星、SK海力士、美光等存儲器供應(yīng)商控制。
用于 PC/數(shù)據(jù)中心/汽車的內(nèi)存 DRAM 封裝主要是由三星、美光、SK 海力士和華邦等頂級內(nèi)存制造商制造的基于 FCCSP 的封裝,”Yole 的 Vaibhav Trivedi 說。
FCCSP 封裝在移動和消費(fèi)市場中占有一席之地,主要用于 PC、服務(wù)器和汽車應(yīng)用中使用的智能手機(jī) APU、RF 組件和 DRAM 設(shè)備。
使用 FCCSP 封裝是因為它們提供低成本和可靠的解決方案,如 WLCSP(晶圓級芯片規(guī)模封裝),而不會產(chǎn)生更高的扇出型封裝成本。
FCCSP 通常是單芯片,只有很少的無源元件,BD 尺寸小于 13 毫米 x 13 毫米,并且通常是包覆成型的,并使用成型底部填充來保護(hù)焊點。
在異構(gòu)集成的競爭中,日月光(帶 SPIL 和 USI)、臺積電、英特爾、Amkor 和 JCET 等主要參與者宣布了 2021 年前所未有的資本支出投資:
臺積電計劃在 2021 年花費(fèi)大約 25至 28 億美元的資本支出,以配備基于 InFO 的設(shè)備、CoWoS 和基于 SoIC 的產(chǎn)品線的新先進(jìn)封裝工廠。臺積電通過其先進(jìn)封裝產(chǎn)品在 2021 年創(chuàng)造了約 36 億美元的收入,并有望在頂級 OSAT 集群中達(dá)到新的高度。
日月光還宣布了估計 20 億美元的資本支出,專門投資于通過 EMS 活動蓬勃發(fā)展的系統(tǒng)級封裝業(yè)務(wù)及其晶圓級封裝業(yè)務(wù)。在收購 SPIL 和 USI 之后,ASE 仍然是頂級的 OSAT。
英特爾將投資 3?5 億美元用于先進(jìn)封裝,以擴(kuò)大其在亞利桑那州和俄勒岡州工廠的 Foveros/EMIB“混合”封裝制造。
先進(jìn)封裝市場2025 年將達(dá)到 420 億美元
Yole Developpement 預(yù)測,先進(jìn)封裝市場預(yù)計將在 2019-2025 年間以 6.6% 的復(fù)合年增長率增長,到 2025 年將達(dá)到 420 億美元。
按按技術(shù)平臺,預(yù)計最高收入復(fù)合年增長率來自 2.5D / 3D 堆疊 IC、嵌入式芯片和扇出,分別占總市場的 21%、18% 和 16%。
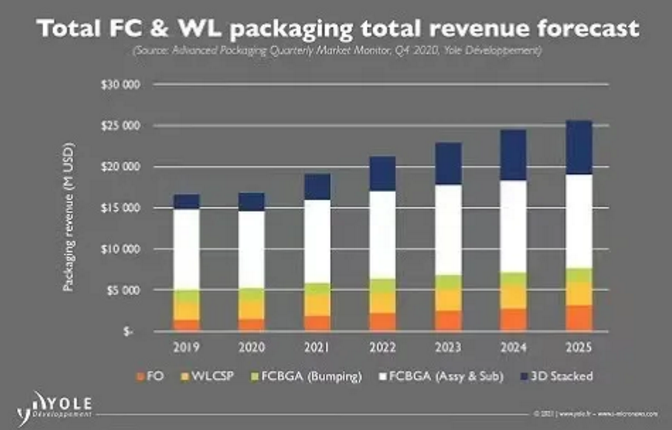
臺積電、英特爾、三星、Amkor、日月光等……都在積極參與先進(jìn)封裝市場空間。
預(yù)計先進(jìn)封裝市場在 2020 年將同比下降 6.8%。然而,Yole 的分析師相當(dāng)樂觀,預(yù)計該市場將在 2021 年反彈。
數(shù)字娛樂、遠(yuǎn)程工作和數(shù)字運(yùn)營規(guī)模的激增所塑造的數(shù)據(jù)驅(qū)動型產(chǎn)品正在加速采用。
例如,移動、網(wǎng)絡(luò)和汽車領(lǐng)域的扇出;AI/ML、HPC、數(shù)據(jù)中心、CIS 和 3D NAND 中的 3D 堆疊;以及汽車、移動和基站中的嵌入式芯片。
按收入細(xì)分,移動和消費(fèi)市場占 2019 年先進(jìn)封裝總收入的 85%,Yole 預(yù)計到 2025 年復(fù)合年增長率為 5.5%,占先進(jìn)封裝總收入的 80%。
與此同時,電信和基礎(chǔ)設(shè)施是收入增長最快的部分。該細(xì)分市場約占先進(jìn)封裝市場總量的 13%。
Yole 的分析師預(yù)計,到 2025 年,它的市場份額將從 2019 年的 10% 增加到 14%。
同時,就收入而言,汽車和運(yùn)輸部門在 2019 年至 2025 年期間將以 10.6% 的復(fù)合年增長率增長,2025 年將達(dá)到約 19 億美元。
