第三代半導(dǎo)體氮化鎵(GaN)材料具有禁帶寬度大、電子飽和速度及電子遷移率高、擊穿場(chǎng)強(qiáng)高等特性[1],使 GaN HEMT 器 件 擁 有 高 頻 率、高功率、耐高溫高壓、抗輻射等優(yōu)點(diǎn),在 射 頻 領(lǐng) 域 有 廣 闊 的 應(yīng) 用 前 景,得到了美國(guó) Cree等半導(dǎo) 體 巨 頭 公 司 的 關(guān) 注[2-4],國(guó)內(nèi)也有北 大、西 電[5]以 及 中 國(guó) 電 科 等 單 位 進(jìn) 行 長(zhǎng) 期 的研究。
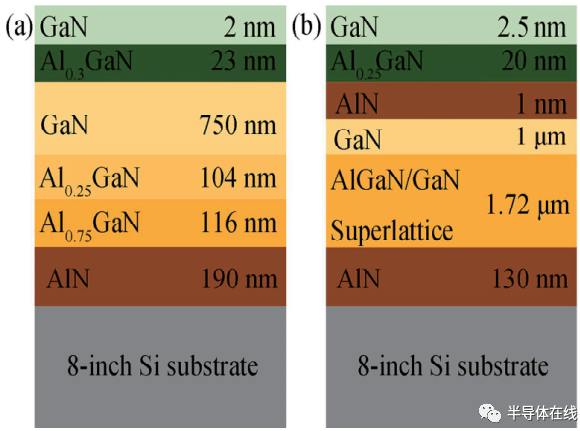
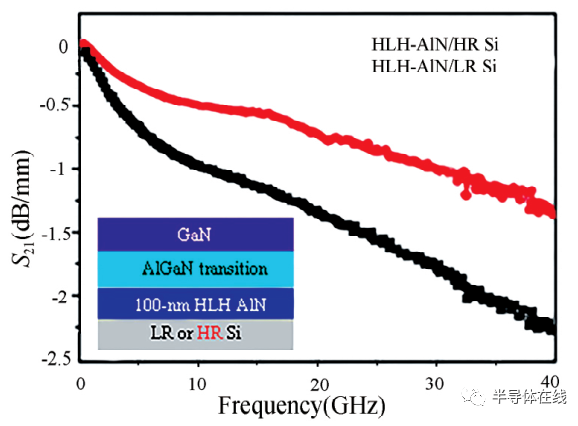
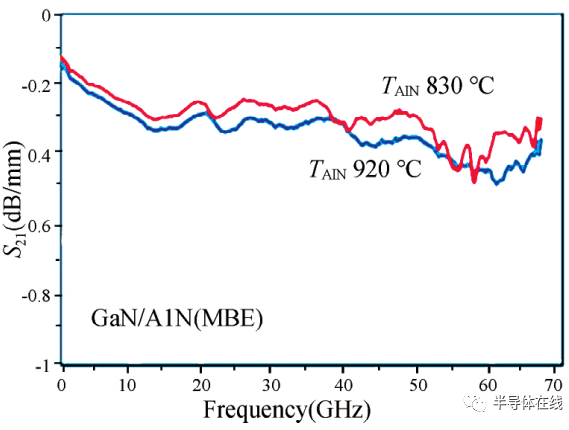
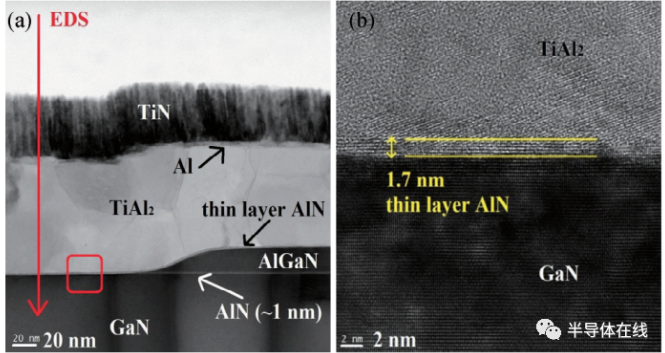

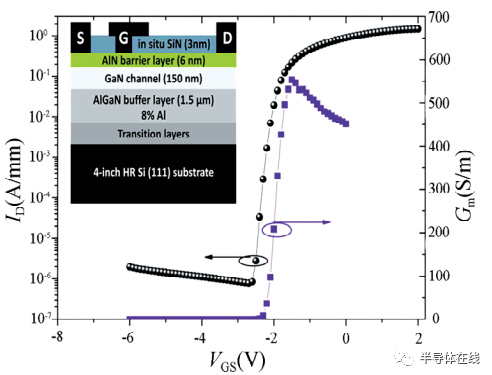
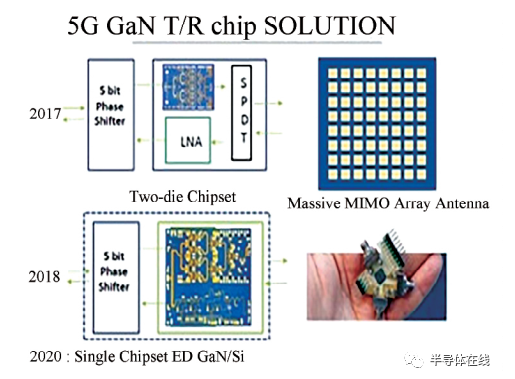
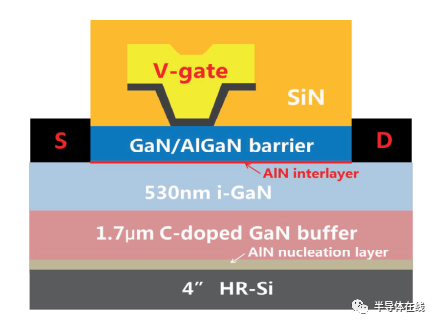
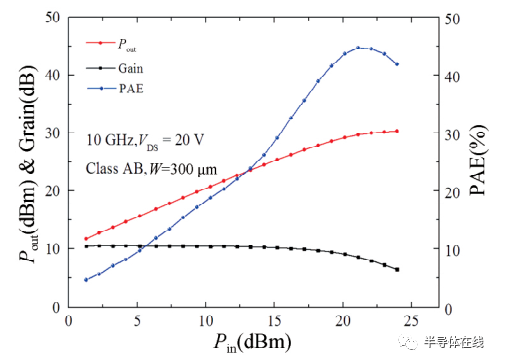
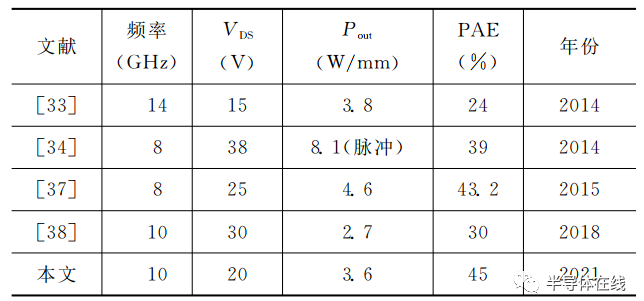
碳化硅(SiC)材 料 的 熱 導(dǎo) 率 高,晶 格 匹 配 性 優(yōu) 異,由其外延 得 到 的 GaN 薄 膜 結(jié) 晶 質(zhì) 量 是 最 優(yōu) 的,然 而SiC襯底的價(jià)格高昂,晶圓 尺 寸 ?。ǎ场?英 寸 為 主),不利于 GaN 射頻器件的產(chǎn)業(yè)化。硅(Si)材料的價(jià)格低廉、晶圓尺寸大(≥6英寸)、熱導(dǎo)率良好,若能解決SiCMOS工藝與 GaN 制備工藝的兼容問(wèn)題,即可低成本、大規(guī)模地生產(chǎn) GaN 射頻器件,進(jìn)而推動(dòng)5G 通信及其他新興技術(shù)的普及應(yīng)用。此外,除 了 傳 統(tǒng) 的 單 一射頻芯片 或 功 率 器 件 外,還 可 利 用 Si工 藝 平 臺(tái) 實(shí) 現(xiàn)GaN 射頻器件與功率器件的單片集成,以及與Si器件的異質(zhì)異構(gòu)集成等,大幅提升電路 性 能 與 集 成 密 度,推動(dòng)智能前端芯片技術(shù)發(fā)展。因此 Si基 GaN 技術(shù)正受到國(guó)內(nèi)外科研院所與產(chǎn)業(yè)界越來(lái)越多的關(guān)注 [6-8]。
本文主要調(diào)研了 近 年 來(lái) 國(guó) 內(nèi) 外 關(guān) 于 Si基 GaN 射頻器件在材料、工 藝 與 電 路 上 的 研 究 進(jìn) 展,剖析了相關(guān)技術(shù)難點(diǎn)與存在問(wèn)題,并展望了 Si基 GaN 射頻器件未來(lái)的優(yōu)化發(fā)展方向。此 外 還 基 于 射 頻 損 耗 較 低 的高阻 Si上 AlGaN/GaN HEMT 材 料,報(bào) 道 了 研 制 的0.25μm 及0.4μm 工藝下的Si基 GaN 射頻器件,經(jīng)測(cè)試在 C波段及 X 波段下工作性能優(yōu)異,揭示了Si基GaN 射頻器件在5G 應(yīng) 用 及 低 成 本 雷 達(dá) 等 領(lǐng) 域 的 獨(dú) 特優(yōu)勢(shì)和應(yīng)用前景。
1.國(guó)內(nèi)外研究現(xiàn)狀
自20世紀(jì)90年代初,Khan等[9]在藍(lán)寶石襯底上率 先 制 得 了 AlGaN/GaN 結(jié) 構(gòu), 隨 后 AlGaN/GaN HEMT 的 直 流 及 微 波 特 性 相 繼 被 報(bào) 道[10-11], 關(guān) 于GaN HEMT器件的研究逐漸成為熱點(diǎn)。由于 GaN 單晶難以制備,GaN HEMT器件一般由異質(zhì)外延生長(zhǎng)得到,所使用 的 襯 底 材 料 有 SiC、藍(lán)寶 石、Si三 種。半絕緣SiC材料由于 具 備 良 好 的 晶 格 匹 配 性 和 優(yōu) 良 的 熱導(dǎo)率,一直是 GaN HEMT 外 延 襯 底 的 最 佳 選 擇。然而,SiC作為襯底存 在 著 晶 圓 尺 寸 小、成本過(guò)高的問(wèn)題,嚴(yán)重限制了 GaN 器件的推廣應(yīng)用。而對(duì)于藍(lán)寶石襯底,其晶圓尺寸 較 大 且 價(jià) 格 較 為 便 宜,但其硬度太高、熱導(dǎo)率極低且晶格失配大,不 利 于 后 續(xù) 加 工 與 應(yīng)用。相較之下,Si襯底上 GaN 技術(shù)不僅具有較好的熱導(dǎo)率和最低的襯底成本,而 且 晶 圓 尺 寸 大,起點(diǎn)6英寸且易升級(jí)到8英寸以上,并可與Si工藝線兼容,具有顯著的成本優(yōu)勢(shì)和 規(guī) 模 化 生 產(chǎn) 能 力。下面將介紹近年來(lái)國(guó)內(nèi)外關(guān)于Si基 GaN 射頻器件的研究進(jìn)展。
1.1Si基 GaN 射頻材料優(yōu)化生長(zhǎng)
Si與 GaN 之間存在的較大晶格失配和熱失配是制約Si基 GaN 技 術(shù) 發(fā) 展 的 主 要瓶頸,由 失 配 產(chǎn) 生 的 位錯(cuò)與應(yīng)力會(huì)嚴(yán)重 影 響 結(jié) 晶 質(zhì) 量,并 惡 化 器 件 性 能。因此如何消除各外延 層 之 間 的 應(yīng) 力,探 究 出 有 效 的 應(yīng) 力調(diào)控技術(shù),是改善 Si基 GaN 射 頻 器 件 各 項(xiàng) 特 性 的 基礎(chǔ)。此外,與電力電子器件不同,Si基 GaN 射頻器件由于高阻Si晶圓難以制備,且襯 底 與 成 核 層 界 面 處 易形成導(dǎo)電層,導(dǎo)致器 件 在 高 頻 工 作 狀 態(tài) 下 存 在 射 頻 損耗,限制輸出功率和效率。因此,如 何 優(yōu) 化 襯 底 及外延結(jié)構(gòu),抑制射頻損耗,是實(shí)現(xiàn) Si基 GaN 射頻器件大規(guī)模高效應(yīng)用的關(guān)鍵。
2019年,Tzeng等[12]在8英寸Si襯底上分別制備了 Al組分漸變 AlGaN 緩沖層和 AlGaN/GaN 超晶格緩沖層 兩 種 結(jié) 構(gòu) 的 GaN HEMT 器 件,如 圖 1 所 示。經(jīng) TEM、XRD、拉 曼 光 譜、AFM、EPD、直 流 特 性以及頻率特性等系統(tǒng)地測(cè)試 分 析 比 較 兩 種 結(jié) 構(gòu) 對(duì) 器 件各項(xiàng)性能指標(biāo)的影響,發(fā)現(xiàn)采用 AlGaN/GaN 超晶格緩沖層結(jié)構(gòu)的器件無(wú)論是結(jié) 晶 質(zhì) 量 還 是 直 流 特 性 或 頻率特性均展現(xiàn)出更優(yōu)的測(cè)試結(jié)果,在0.17 μm 柵長(zhǎng)下測(cè)得fT和fmax分別達(dá)到41.6GHz和126.46GHz。同年 Yang等[13]設(shè)計(jì)了Si摻雜的 AlGaN 背勢(shì)壘層以及 C摻雜的 GaN 緩沖層得到了漏電小、耐擊穿且電流崩塌效 應(yīng) 低 的 Si基 AlGaN/GaN HEMT 器 件。2020 年,Xia等[14]分 析 了 GaN 和 SiN 兩 種 不 同 帽 層 結(jié) 構(gòu) 對(duì)AlN/GaN HEMT器 件 性 能 退 化 的 抑 制 效 果,發(fā) 現(xiàn) 帶有3.5nm 原位鈍化SiN 帽層以及4.5nm AlN 勢(shì)壘層結(jié)構(gòu)的Si基 GaN HEMT 器 件 具 有 最 低 的 薄 層 電 阻、最 高 的 二 維 電 子 氣 濃 度 (Two-DimensionalElectron GasDensity)以及最好的穩(wěn)定性。
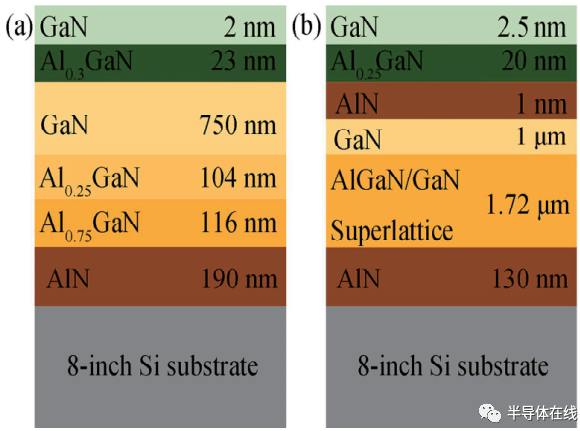
圖1 采用組分漸變 AlGaN 的緩沖層結(jié)構(gòu)(a)和 AlGaN/GaN超晶格的緩沖層結(jié)構(gòu)(b)[12]
2017年,Luong等[15]采 用 HLH Temperature的生長(zhǎng)模式在高阻Si襯底(104 Ω·cm)上外延出100nm的 AlN 緩 沖 層,得 到 的 GaN HEMT 有 效 抑 制 了 因AlN/Si之間晶格失配所產(chǎn)生的張應(yīng)力,從而降低極化電場(chǎng)強(qiáng)度,減小射頻損耗。通過(guò)對(duì)長(zhǎng)度為1 mm 的共面波導(dǎo)(CPW)測(cè) 試,10 GHz下 射 頻 損 耗 僅 0.4dB/mm,40GHz下的射頻損耗低于1.2dB/mm,材料結(jié)構(gòu)及測(cè)試結(jié)果如 圖 2 所 示。同 年,Cordier等[16]采 用NH3-MBE技術(shù),在高阻Si襯底(104 Ω·cm)上生長(zhǎng)了0.2μm 的 AlN 成核層和0.5 μm 的 GaN 緩沖層,此生長(zhǎng)模式相較于 MOCVD 更易控制 AlN/Si間的界面態(tài),且其低溫生長(zhǎng)特性 能 在 抑 制 界 面 態(tài) 漏 電 的 同 時(shí) 保證高結(jié)晶質(zhì)量。經(jīng)測(cè)試35GHz下的射頻損耗低于0.3dB/mm,且70GHz下的射頻 損 耗 低 于0.5dB/mm,并對(duì)比了不同 AlN 生長(zhǎng)溫度 對(duì) 射 頻 損 耗 的 影 響,如圖3所示。此外,Chiu等[17]利用絕緣襯底上硅(SOI)制備 了 AlGaN/GaN MISHEMT, 采 用 SOI 襯 底 的HEMT器件具有低寄生電容、低射頻損耗、高襯底絕緣度等適用于射頻器件的優(yōu)點(diǎn),經(jīng)測(cè)試0.25 μm 柵長(zhǎng)下fT和fmax分別達(dá)32.1GHz和51.9GHz。
可以看出合理的帽層、勢(shì) 壘 層 以 及 緩 沖 層 等 結(jié) 構(gòu)設(shè)計(jì)不但能夠調(diào)控應(yīng) 力 提 高 結(jié) 晶 質(zhì) 量,還能使器件具備優(yōu)異的直流特性和頻率特性,與 此 同 時(shí) 要 優(yōu) 化 襯 底及成核層結(jié) 構(gòu) 以 求 降 低 射 頻 損 耗,一 方 面 可 以 提 高AlN 的結(jié)晶質(zhì)量并抑制 AlN/Si間的界面態(tài),另一方面應(yīng)從緩 沖 層 及 Si襯 底 入 手,提 高 器 件 絕 緣 度,減 小漏電。
圖片
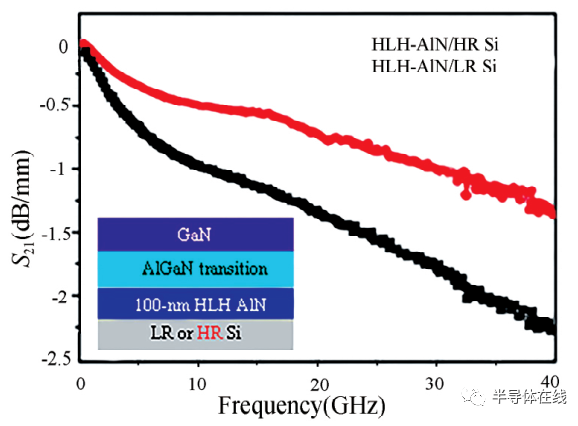
圖2 高低阻Si襯底上外延100nm HLH AlN 的射頻損耗[15]
1.2 無(wú)金的Si基 GaN 工藝技術(shù)
現(xiàn)有的Si基 射 頻 GaN 器 件 制 造 工 藝 幾 乎 都 是 基于有金(Au)工藝 完 成 的。Au是 傳 統(tǒng) GaN 器 件 歐 姆 接觸工藝中的必 備 金 屬 之 一,采 用 Ti/Al/X/Au(X 可 為Ti、Ni、Mo、Pt等)結(jié) 構(gòu) 合 金 的 接 觸 電 阻 可 達(dá) 到0.3Ω·mm 左 右,且 性 能 穩(wěn) 定。然 而,含 Au的 GaN 制備工藝存在著成本高以及與傳統(tǒng) CMOS工 藝 不 兼 容 等問(wèn)題,提高了 Si基 GaN 射 頻 器 件 的 生 產(chǎn) 成 本。實(shí) 現(xiàn)無(wú) Au工藝的關(guān)鍵是做到源漏金屬的無(wú) Au化,對(duì)此已有 Ti/Al/TiN、Ti/Al/Ti/TiN、Ti/Al/W、Ti/Al/Ti/TiW、Ti/Al/Ni/Pt、Ti/Al/NiV 等 方 案 提 出,所 獲 得的歐姆接觸電阻 一 般 在0.5~1.0Ω·mm,盡 管 這 些方案能夠 一 定 程 度 地 滿 足 電 力 電 子 功 率 器 件 的 需 求,然而面對(duì)射頻器件對(duì) 寄 生 電 阻 的 嚴(yán) 格 要 求 仍 存 在 較 大的差距。
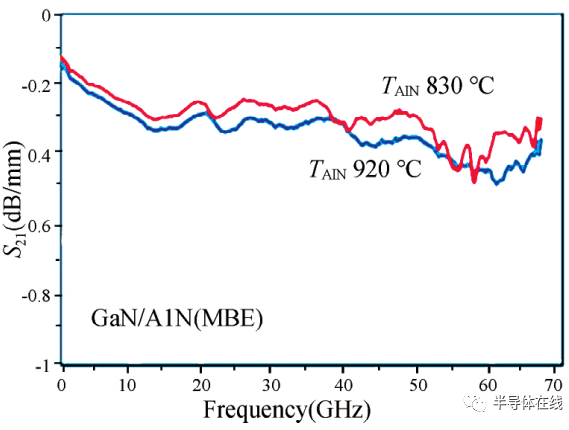
圖3 不同溫度下采用 NH3-MBE技術(shù)生長(zhǎng) GaN/AlN緩沖層的射頻損耗對(duì)比[16]
2017年,Ferreyra等[18]采 用 脈 沖 激 光 燒 蝕 技 術(shù)(PLD),在Si襯 底 上 制 備 了 表 面 光 滑 且 形 貌 良 好 的n+ -GaN,并在 其 上 淀 積 Hf/Al/Ti(20/200/20nm)形成無(wú) Au歐姆接觸,此外 Hf金屬的功函數(shù)(3.5eV)低于 Ti(4.1eV)與 TiN(4.7eV),故 更 適 合 作 為 歐 姆 接觸的 電 極,經(jīng) 測(cè) 試 得 到 接 觸 電 阻 為0.17Ω·mm,比接觸 電 阻 可 達(dá) 10-7 Ω·cm2 量 級(jí)。2018 年,Zhang等[19]在Si襯 底 上 經(jīng) 勢(shì) 壘 層 刻 槽 處 理 后,采 用 Ti/Al/Ti/TiN (2.5/100/20/60nm)的 無(wú) Au歐 姆 接 觸 工 藝 制備了 AlGaN/GaN HEMT 器 件,退 火 后 的 結(jié) 構(gòu) 如 圖4所示。其中底 層 金 屬 Ti的 厚 度 僅 為2.5nm,既 能 夠形成厚度適宜 的 TiN 層 讓 Al與 TiN 發(fā) 生 固 相 反 應(yīng) 生成 AlN,又不會(huì)因 Ti太厚而阻止兩者反應(yīng),使接觸電阻大大降低,在550 ℃下 合 金 得 到 的 接 觸 電 阻 與 比 接觸電阻分別為0.21Ω·mm 和1.16×10-6 Ω·cm2。
可見(jiàn)采 用 二 次 外 延 高 質(zhì) 量 n+ -GaN、勢(shì) 壘 層 刻 槽以及無(wú) Au歐 姆 接 觸 等 技 術(shù),能 夠 得 到 較 低 的 接 觸 電阻和比接觸 電 阻 并 改 善 表 面 形 貌。此 外 無(wú) Au的 歐 姆接觸工藝也為實(shí)現(xiàn)無(wú) Au的Si基 GaN 技術(shù),降低生產(chǎn)成本提供了保障。
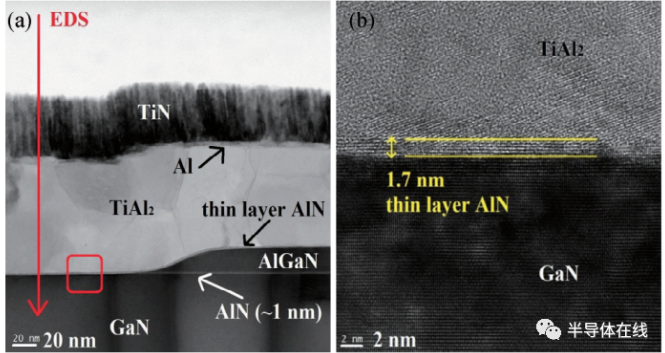
(a)合金退火后金屬結(jié)構(gòu);(b)合金與半導(dǎo)體接觸面結(jié)構(gòu)
圖4 Ti/Al/Ti/TiN 在550 ℃退火后的 HR-TEM 圖[19]
1.3 復(fù)合鈍化的Si基 GaN 工藝技術(shù)
為了 解 決 Si基 GaN 射 頻 器 件 的 電 流 崩 塌 問(wèn) 題,一般需要在器件表面淀積 SiN 鈍化保護(hù)層,其能夠有效抑制表面態(tài)對(duì)電子的俘獲效應(yīng),從而抑制電流崩塌,但是與此同時(shí)溝道的 電 子 濃 度 也 會(huì) 提 高,短溝道效應(yīng)也隨之加劇,惡 化 輸 出 特 性 和 關(guān) 斷 特 性。此外SiN 鈍化層通常由PECVD 低溫生長(zhǎng)得到,此工藝會(huì)導(dǎo)致SiN薄膜中 H 離子雜質(zhì)過(guò)多且致密性較差,鈍化效果不理想。并且由于Si襯底的絕緣度遠(yuǎn)不如SiC 襯底,漏電問(wèn)題也嚴(yán)重制約著 Si基 GaN 射 頻 器 件 的 性 能。因此探究高水平的先進(jìn)鈍化工藝是 有 效 抑 制 電 流 崩 塌 和 表面漏電的關(guān)鍵技術(shù)方案。LPCVD 不同于 PECVD,是一種高溫鈍化SiN 的工藝,通 常 在 器 件 工 藝 開 始 前 完成,生長(zhǎng)得到 的 鈍 化 層 致 密 性 好、質(zhì)量高。原位鈍化MOCVD 是一種在 GaN 生長(zhǎng)結(jié)束后繼續(xù)生長(zhǎng)SiN 保護(hù)層的方法,能夠有效避 免 器 件 表 面 受 到 外 界 環(huán) 境 的 污染,故鈍化效果良好。
2019年,Zhang等[20]采 用 LPCVD 技 術(shù) 在 GaN表面生長(zhǎng)了一層20nm 的 SiN 鈍化層,經(jīng) CV 測(cè)試分析發(fā)現(xiàn)由 LPCVD 生 長(zhǎng) 的 鈍 化 層 相 較 于 PECVD 具備更好的致 密 性,并 且 能 夠 有 效 抑 制 表 面 漏 電。2020年,Chen等[21]采用原位鈍化 MOCVD 技術(shù)在勢(shì)壘層上生長(zhǎng)了3nm 的SiN 作為柵介質(zhì),制得0.7μm 柵長(zhǎng)的 AlGaN/GaN MISHEMT 器件性能良好,電路開關(guān)比達(dá)106,電流退化率為18%,測(cè)得fT和fmax分別為12.5GHz和15GHz。為了比較 PECVD、LPCVD 復(fù)合鈍化以及原位鈍化 MOCVD 對(duì)電流崩塌以及表面漏電的抑制作用,Huang等[22]用 上 述 三 種 不 同 的 方 式 在同種器件結(jié)構(gòu)上制備了三種SiN 鈍化層,鈍化效果對(duì)比 如 圖 5 所 示, 可 以 看 出 LPCVD 復(fù) 合 鈍 化 層(Bilayer)的曲線波動(dòng)是最小的,說(shuō) 明 該 種 鈍 化 方 式 對(duì)電流崩塌和表面漏電的抑制效果最好。
為在 抑 制 電 流 崩 塌 的 同 時(shí) 減 小 漏 電, 并 改 善PECVD 鈍化帶來(lái)的致密性差、H 離 子 雜 質(zhì) 多 等 問(wèn)題,可采用原位鈍化 MOCVD 以及 LPCVD 生長(zhǎng)高質(zhì)量的鈍化層。然而致密 性 過(guò) 高 的 鈍 化 層 難 以 刻 蝕,會(huì)影響后續(xù)器件工藝開展,對(duì) 此 可 采 用 復(fù) 合 鈍 化 的 辦 法,在一層較薄的原位鈍化 MOCVDSiN 或 LPCVDSiN 上通過(guò)PECVD 繼續(xù)生長(zhǎng)SiN,最終形成的高質(zhì)量復(fù)合鈍化層既有很好的保護(hù)作用又便于后續(xù)器件工藝的進(jìn)行。

(a)電流響應(yīng);(b)陷阱時(shí)間常數(shù)
圖5 三種鈍化層的效果對(duì)比[22]
1.4 Si基 GaN 射頻器件與電路設(shè)計(jì)
伴隨著材料結(jié)構(gòu)設(shè)計(jì)和器件制備工藝的持續(xù)改進(jìn),Si基 GaN 射頻器件及其電路的性能也不斷刷新著行業(yè)記錄。
在微波毫 米 波 頻 率 特 性 方 面,早 在 2004 年 法 國(guó)GaN 研究中心(IEMN)的 Minko等[23]率 先 在 電 阻 率 為20kΩ·cm 的高阻Si襯底上制備了柵長(zhǎng)為170nm,且AlGaN 勢(shì)壘層厚度為30nm 的 GaN HEMT射頻器件,當(dāng)源漏電 壓 為 10 V,柵 電 壓 為 1 V 時(shí),輸 出 電 流 為0.55A/mm,fT和fmax分別為46GHz和92GHz;并在2013年 Bouzid等[24]將 AlGaN 勢(shì)壘層的厚度降低到12.5nm,柵長(zhǎng)縮短到90nm,當(dāng)源漏電壓為5V,柵電壓為 -2.1 V 時(shí), 測(cè) 得 fT 和 fmax 分 別 提 高 到 100GHz 和 206 GHz。2009 年, 瑞 士 聯(lián) 邦 理 工 學(xué) 院(EPFL)與 蘇 黎 世 聯(lián) 邦 理 工 學(xué) 院(ETH)合作[25],采用17.5nm Al0.26Ga0.74N 勢(shì)壘層,柵長(zhǎng)為100nm,源漏電壓為2.5V,柵電壓為-2V 時(shí),輸出電流為0.75A/mm,fT和fmax分別為101GHz和128GHz;2015年 Marti等[26]采 用 3.5nm 厚 的 AlInN 作 為 勢(shì) 壘 層,制備了柵長(zhǎng)為50nm 的 AlInN/GaN HEMT 器件,源漏電壓5V,柵電壓2V 時(shí),輸出電流為1.6A/mm,fT和fmax分別提升至141GHz和232GHz。新加坡南洋理工大學(xué)(NTU)在大尺寸硅基 GaN 材料外延與器件制備方面也進(jìn) 行 了 大 量 的 研 究,2012年 Ng等[27]基于8英寸Si晶圓制備了柵長(zhǎng)為0.3μm 的Si基 GaN 射頻器件,源漏電壓為10V,柵電壓為-2V 時(shí),測(cè)試得到fT和fmax分別為28GHz和64GHz;接著在2014年 Ranjan等[28]又 報(bào) 道 了 基 于 高 阻 Si襯 底 的 T 型 柵AlGaN/GaNHEMT器件,其采用了厚度僅為8nm 的AlGaN 勢(shì)壘層,柵長(zhǎng)為0.15 μm,經(jīng)測(cè)試fT和fmax分別達(dá) 到 了 63 GHz和 128 GHz,擊 穿 電 壓 為 132 V,Johnson品質(zhì)因子高達(dá)8.32THz·V。此外,在2018年他們還與 MIT 合作[29]報(bào)道了40nm 柵長(zhǎng)的I型 柵InAlN/GaN HEMT器件,測(cè)得fT和fmax分別達(dá)到250GHz和60GHz。同年,南京電子 器 件 研 究 所 與 蘇 州納米所合作[30]報(bào)道了55nm 柵長(zhǎng)的 T 型柵 AlGa(In)N/AlN/GaNHEMT器件,經(jīng)測(cè)試fT和fmax分別為145GHz和220GHz,可與國(guó)外先進(jìn)研究成果相媲美。
在微波功率方面,日本 OKI公司的Shinichi等[31]在2009年就有相關(guān)研究成果報(bào)道,在源漏電壓為70V,工作頻率為2.14GHz時(shí),測(cè)試高阻Si基 GaN 射頻器件功率 特 性,得 到 輸 出 功 率 密 度 (Pout)達(dá) 12.88W/mm,最大功率附加效率(PAE)達(dá)64%,測(cè)試結(jié)果表明Si基 GaN 在射頻應(yīng) 用 方 面 存 在 巨 大 潛 力;同年,瑞士聯(lián)邦理工學(xué)院的 Sun等[25]基于9nm 厚的 AlInN勢(shì)壘層,研制了柵長(zhǎng)為100nm 的Si基 GaN HEMT器件,在源漏電壓為15V,工作頻率為10GHz時(shí)測(cè)得Pout為 2.5 W/mm,PAE 達(dá) 23%;2012 年,Chang等[32]采用斜場(chǎng)板結(jié)構(gòu)研制的Si基 AlGaN/GaN 器件在8GHz下 Pout達(dá)到了5 W/mm;2014年,日本瑞薩電子的 Yasuhiro等[33]制備了柵長(zhǎng)為0.16 μm 的 T 型柵AlGaN/GaN HEMT器件,源漏電壓為30V,工作頻率為14GHz時(shí),Pout為3.82 W/mm;同 年,首 爾 大學(xué)的 Lee等[34]報(bào)道了研制的Si基 AlGaN/GaN HEMT器件在 8 GHz下 的 功 率 性 能,脈 沖 輸 出 功 率 達(dá) 8.1W/mm(脈寬為100μm,占空比為10%),功率增益為8dB,PAE達(dá)39%,總功率接近30 W。
在 毫 米 波 功 率 方 面, 法 國(guó) IEMN 的 Medjdoub等[35]于2012年 在 4 英 寸 高 阻 Si襯 底 上 制 備 了 AlN/GaN HEMT器件并展示了首個(gè)40GHz頻率下的功率測(cè)試結(jié)果,得 到 Pout為 2.5 W/mm,器 件 結(jié) 構(gòu) 及 ID-VGS曲線如圖6所示;2013年 Medjdoub 等[36]又將 40GHz下 的 Pout提 高 到 3.2 W/mm;2015 年 ETH 的Marti等[26]報(bào)道了國(guó)際上首個(gè) W 波段 Si基 GaN 射頻器件,工作頻率為94GHz時(shí),Pout達(dá)1.35 W/mm。
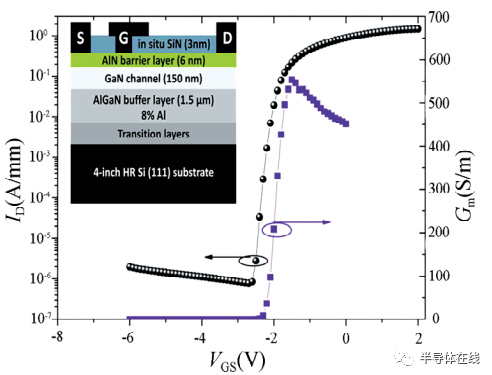
圖6 IEMN 制備的毫米波器件結(jié)構(gòu)及其ID -VGS曲線[35]
在產(chǎn)品方面,近年來(lái)在5G 通 信 技 術(shù) 和 先 進(jìn) 低 成本相 控 陣 雷 達(dá) 得 到 越 來(lái) 越 廣 泛 應(yīng) 用 的 大 背 景 下,OMMIC、MACOM、IMEC 以 及 MIT 等 海 外 巨 頭 公司和機(jī)構(gòu)紛紛加大投入,在器件性能、成本和技術(shù)等方面展現(xiàn)出 卓 越 的 市 場(chǎng) 競(jìng) 爭(zhēng) 實(shí) 力,其 中 代 表 公 司 有MACOM 和 OMMIC。
MACOM 公司自2014年起著力研究 Si基 GaN 技術(shù),并逐漸將重心從SiC基 GaN 芯片轉(zhuǎn)移過(guò)來(lái),截至目前已經(jīng)開發(fā)了多代Si基 GaN 射頻器件,向通信、軍事以及其他應(yīng)用領(lǐng)域的客 戶 提 供 了 上 百 萬(wàn) 件 基 于Si基GaN技術(shù)的產(chǎn)品。采用標(biāo)準(zhǔn)的0.5μm HEMT工藝制程制備的分立 及 集 成 放 大 器,能夠在直流到6GHz的超寬頻帶范圍內(nèi)工作,同時(shí)產(chǎn)品的增益、增益平坦度、效率以及 穩(wěn) 定 性 均 處 于 行 業(yè) 領(lǐng) 先 水 平,如 NPTB00004A
型寬帶 GaN晶體管在28V工作電壓以及2.5GHz頻率下的線 性 增 益 達(dá) 14.8dB,Pout為 5 W,且 PAE 超 過(guò)55%,憑借其超 寬 的 工 作 頻 率 范 圍 可 應(yīng) 用 于 L/C波段雷達(dá)、無(wú)線通信 以 及 航 空 航 天 等 領(lǐng) 域。此外 MACOM公司還于2018年宣布了與意法半導(dǎo)體(ST)的合作計(jì)劃,由ST協(xié)助 MACOM 生產(chǎn)晶圓,顯著提升了Si基 GaN射頻芯片的產(chǎn)能以及國(guó)際競(jìng)爭(zhēng)力。
OMMIC公司于2006年 開 始 Si基 GaN 毫 米 波 功放的研究,并于2015年開發(fā)出100nm 制程下的Si基GaN 器件 制 備 工 藝 技 術(shù) (D01GH), 在 30 GHz 時(shí),Pout達(dá)3.3 W/mm,40GHz下的噪聲系數(shù)為 1.5dB,已接近 SiC 基 GaN 器件性能。緊接著在2016年公布了首個(gè)基于Si基 GaN 技術(shù)的高性能 T/R 芯片,能夠在37~43GHz頻率范圍內(nèi)工作,40GHz下的總輸出功率達(dá)10 W,且 PAE達(dá)30%,實(shí)現(xiàn)了低噪放、功放以及開關(guān)的單片集成,可 較 好 地 應(yīng) 用 于 雷 達(dá)、通信以及航空等領(lǐng)域。目前 OMMIC 公 司 已 具 備 全 球 領(lǐng) 先 的6英 寸 Si基 GaN 生 產(chǎn) 線, 并 且 制 程 推 進(jìn) 到 60nm(D006GH),未來(lái)將繼續(xù)向下開發(fā)40nm 線寬的Si基GaN 制程,并向市場(chǎng)提供功放、低噪放、開關(guān)以及移相器完全集成,且兼容增強(qiáng)型和耗盡型器件的 T/R 芯片單片化方案,其 T/R 芯片的發(fā)展路線如圖7所示??梢?jiàn) 盡 管 Si基 GaN 器 件 在 性 能 方 面 與 SiC 基GaN 器件相比還存在差距,但 是 隨 著 材 料 生 長(zhǎng) 技 術(shù) 和器件制備工藝的逐漸成熟,Si基 GaN 器件的截止頻率和功率密度 等 主 要 參 數(shù) 都 在 逐 步 提 高,未 來(lái) 達(dá) 到 與SiC基 GaN 相媲美的 性 能 指 日 可 待。同時(shí)微波毫米波頻段下基于 Si基 GaN 射 頻 器 件 的 產(chǎn) 品 也 陸續(xù)得以發(fā)布,展現(xiàn)出了巨大的競(jìng)爭(zhēng)潛力,相 信 在 未 來(lái) 將 逐 步 占據(jù)更大的市場(chǎng)份額。
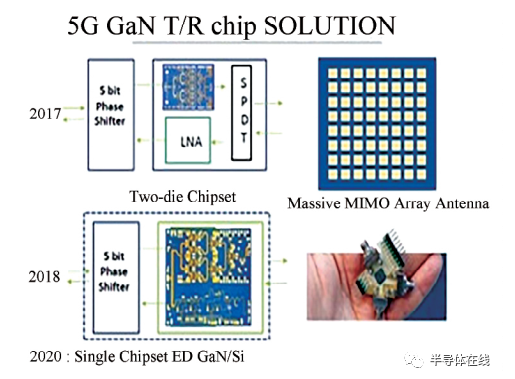
圖7 OMMIC公司發(fā)布的0.1μmSi基 GaN 收發(fā)芯片
2 Si基 GaN 射頻器件研制
圖8為 制 備 的 0.25 μm 和 0.4 μm 柵 長(zhǎng) 的 Si基GaN 材料與器件結(jié)構(gòu)示意圖,本 結(jié) 構(gòu) 的 外 延 層 總 厚 度僅有2μm 左右,既能滿足典型28V 電壓下的正常射頻工作,又可確保材 料 具 備 較 低 的 熱 阻,同時(shí)對(duì) GaN緩沖層進(jìn)行一定濃度的 C 摻雜后 測(cè) 得 射 頻 損 耗(0.72dB/mm@4GHz)已接近SiC基 GaN 材料的結(jié)果(0.54dB/mm@4GHz),此 外 還 采 用 了 基 于 難 熔 W 金屬的疊層 V 型 柵 結(jié) 構(gòu),以 得 到 更 大 的 擊 穿 電 壓 和 更 高 的頻率。
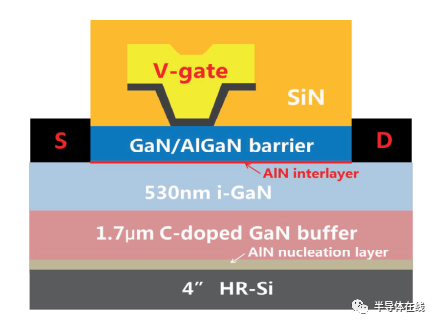
圖8 Si基 GaN 射頻材料與器件結(jié)構(gòu)示意圖
經(jīng)直流 測(cè) 試,0.25 μm 器 件 的 最 大 電 流 密 度(IDS.max)達(dá)0.97A/mm,峰值跨導(dǎo)(Gm.max)為0.29S/mm,0.4μm 器 件 的 IDS.max為 0.95 A/mm,Gm.max為0.26S/mm。此外按照IDS=1mA/mm 的標(biāo)準(zhǔn),0.25μm 和0.4μm 器 件 的 擊 穿 電 壓 均高于80V,滿足28V 工作需求。頻率方面,經(jīng)測(cè)試去嵌后0.4 μm 器件的fT和fmax分 別 為 27 GHz和 33 GHz;而 根 據(jù) -20dB/dec斜率外推 |h21 |2和 MSG/MAG,得0.25μm器件的fT和fmax分別為35GHz和42GHz。
經(jīng) Load-Pull連續(xù)波功率測(cè)試,0.4 μm 器件在頻率為4GHz,電壓為28V 下 的 線 性 增 益 高 達(dá)17dB,PAE約為50%,Pout為4.5 W/mm。圖9顯示了0.25μm 器件在10GHz的測(cè)試結(jié)果,源 漏 偏 置 電 壓 為20V,線性增益為12.3dB,Pout為3.6 W/mm,PAE 約為45%。
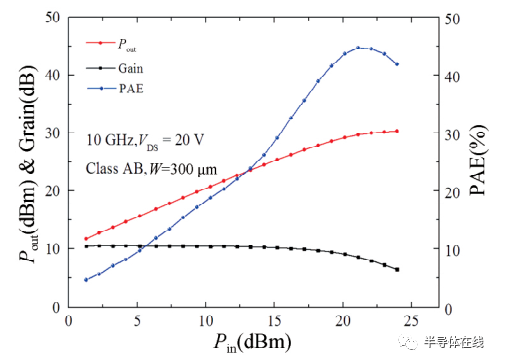
圖9 10GHz時(shí)Si基 GaN 器件的功率特性
此外,還將0.25 μm 工藝 Si基 GaN 射頻器件在10GHz左右的 功 率 特 性 分 別 與 國(guó) 外 研 究 成 果 進(jìn) 行 對(duì)比,如表1所示,可見(jiàn)研制的Si基 GaN 射頻器件功率特性良好,達(dá)到國(guó)際先進(jìn)水平。
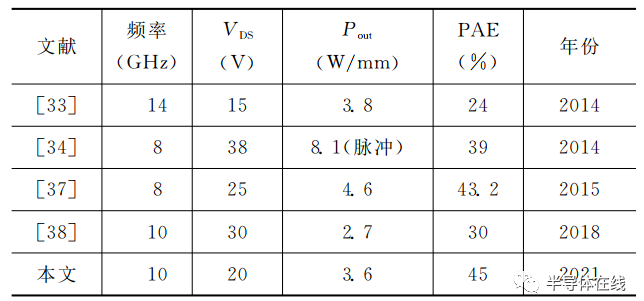
表1 Si基 GaN 射頻器件在 X 波段下功率特性對(duì)比
3 總結(jié)與展望
通過(guò)對(duì) Si基 GaN 射 頻 器 件 在 材 料 生 長(zhǎng)、器件制備以及器件性能等方面的調(diào)研分析,介紹了改善Si基GaN 材料結(jié)構(gòu) 缺 陷 并 優(yōu) 化 器 件 制 備 流 程 的可靠途徑。材料方面,超 晶 格 緩 沖 層、背 勢(shì) 壘 層、C 摻 雜 GaN層、高質(zhì)量成核層、GaN 帽 層 以 及 高 絕 緣 度 襯 底 等 結(jié)構(gòu)設(shè)計(jì),均有助于 改 善 晶 格 失 配、漏 電 及 射 頻 損 耗 等問(wèn)題,而面向于射頻領(lǐng)域的 Si基 GaN 材料結(jié)構(gòu)還應(yīng)控制外延層厚度 以 獲 得 較 低 的 熱 阻;工藝方面,為最大降低成本,無(wú) Au工藝是必要選擇,對(duì)于無(wú) Au歐姆接觸工藝,結(jié)合二次外延 n+ -GaN 以及勢(shì)壘層刻槽等技術(shù)有助于提升表面 形 貌 并 降 低 接 觸 電 阻,同時(shí)結(jié)合PECVD、原位鈍化和 LPCVD 的復(fù)合 鈍 化 工 藝 在 對(duì) 表面的保護(hù)和漏電的抑制方面均表現(xiàn)出良好的效果。
低成本、批量化的生產(chǎn)Si基 GaN 射頻器件是5G通信、射頻源等應(yīng) 用 實(shí) 現(xiàn) 的 重 要 保 障。盡管目前國(guó)內(nèi)外各研究機(jī)構(gòu)在 Si基 GaN 射 頻 材 料 外 延 與器件性能方面取得了一定進(jìn)展,但是性能上與SiC襯底 GaN 相比仍然存在較大差距,而且可靠性 未 得 到 長(zhǎng) 期 驗(yàn) 證,離產(chǎn)業(yè)化尚存在較大距離。未來(lái),通 過(guò) 提 高 外 延 材 料質(zhì)量,開發(fā)兼容 CMOS的大尺寸制造工藝,提高Si基GaN 器件與電路芯片性能,降低生產(chǎn)成本,有望推動(dòng)GaN 射頻技術(shù)在各類民生領(lǐng)域的普及應(yīng)用。
