近日,以“創(chuàng)芯生態(tài) 碳索未來”為主題的第七屆國際第三代半導體論壇暨第十八屆中國國際半導體照明論壇(IFWS & SSLCHINA 2021)在深圳會展中心舉行。本屆論壇由第三代半導體產業(yè)技術創(chuàng)新戰(zhàn)略聯(lián)盟(CASA)、國家半導體照明工程研發(fā)及產業(yè)聯(lián)盟(CSA)聯(lián)合主辦,北京麥肯橋新材料生產力促進中心有限公司與半導體產業(yè)網(wǎng)共同承辦。

期間,“氮化鎵功率器件“分會上,美國Analog 設備公司IC電源控制組設計工程師張薇葭做了題為”基于直接鍵合工藝液冷散熱技術的緊湊型氮化鎵功率模塊設計及其熱學模型研究“的線上主題報告。隨著氮化鎵(GaN) HEMT 器件在光伏逆變器,能量存儲系統(tǒng),電動車輛等工業(yè)領域中逐漸得到應用,氮化鎵器件得以快速發(fā)展并帶動氮化鎵產業(yè)的進步。常見的封裝類型涵蓋傳統(tǒng)通孔式封裝(如TO系列),引腳表面貼裝以及無引腳 DFN,QFN,LGA,BGA 等封裝。為進一步減小寄生電感,GaN功率模塊引入了將驅動電路和GaN HEMT集成封裝的方案。此方案雖進一步減小模塊體積以及提升功率密度,但其導致模塊溫度大幅提高最終引發(fā)模塊中的熱擊穿,或將降低系統(tǒng)可靠性。因此優(yōu)化封裝中,減小寄生和提升散熱效率已成為提升功率模塊性能和可靠性的關鍵?,F(xiàn)行主流德州儀器開發(fā)的驅動系統(tǒng)一般針對LGA或BGA封裝,以最小化寄生電感和寄生電阻。在沒有散熱器的場景下,熱耗散的唯一渠道是通過器件和PCB與外部環(huán)境對流。
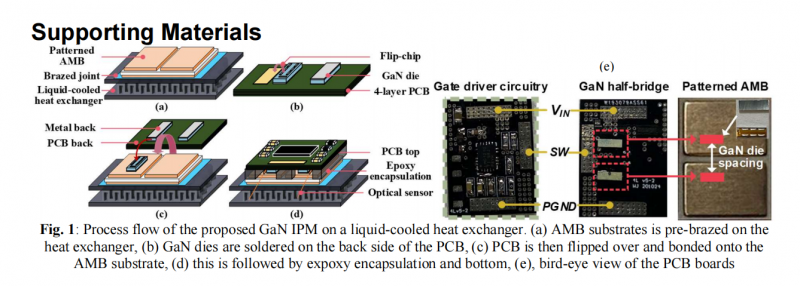
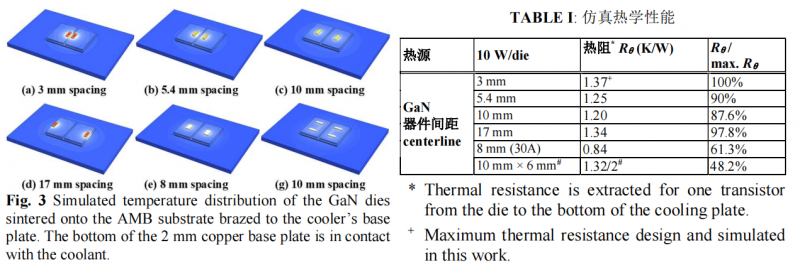
結合關鍵技術與具體實驗數(shù)據(jù)及分析,研究提出新型GaN模塊設計使用低溫(200 °C)無壓銀燒結,將GaN功率模塊直接鍵合在定制熱交換器上以大幅增加熱耗散效率以提高模塊性能。 報告指出,基于直接鍵合工藝液冷散熱技術的緊湊型氮化鎵功率模塊方案可進一步優(yōu)化封裝熱阻和寄生電感并減小PCB板的面積,從而實現(xiàn)高速裝換并有效減小動態(tài)損耗。研究將進一步比較其他的GaN模塊封裝方案及討論其在電動車輛等工業(yè)領域中的前景。
(內容根據(jù)現(xiàn)場資料整理,如有出入敬請諒解)
