近日,第七屆國(guó)際第三代半導(dǎo)體論壇暨第十八屆中國(guó)國(guó)際半導(dǎo)體照明論壇(IFWS & SSLCHINA 2021)在深圳會(huì)展中心舉行。
 期間,“氮化物半導(dǎo)體襯底與外延技術(shù)“分論壇上,中鎵半導(dǎo)體科技有限公司顧問(wèn)劉強(qiáng)做了題為“2英寸低位錯(cuò)密度高電導(dǎo)率和半絕緣氮化鎵自支撐襯底的生長(zhǎng)”的主題報(bào)告,結(jié)合用于PA應(yīng)用的HEMT、用于LD的高導(dǎo)電GaN襯底、用于PND的高導(dǎo)電GaN 襯底的狀況,分享了應(yīng)力和錯(cuò)位控制、電導(dǎo)控制的研究進(jìn)展。
期間,“氮化物半導(dǎo)體襯底與外延技術(shù)“分論壇上,中鎵半導(dǎo)體科技有限公司顧問(wèn)劉強(qiáng)做了題為“2英寸低位錯(cuò)密度高電導(dǎo)率和半絕緣氮化鎵自支撐襯底的生長(zhǎng)”的主題報(bào)告,結(jié)合用于PA應(yīng)用的HEMT、用于LD的高導(dǎo)電GaN襯底、用于PND的高導(dǎo)電GaN 襯底的狀況,分享了應(yīng)力和錯(cuò)位控制、電導(dǎo)控制的研究進(jìn)展。
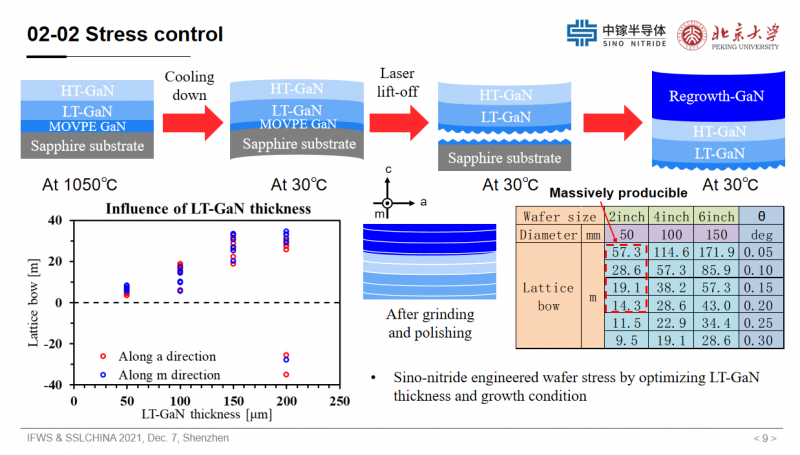
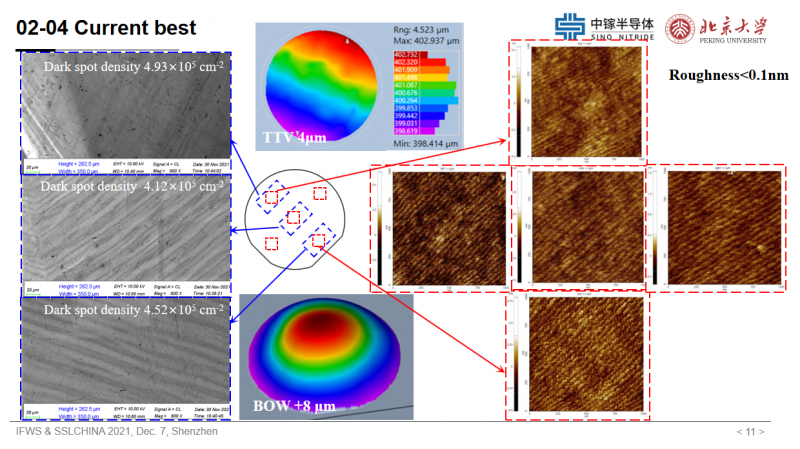
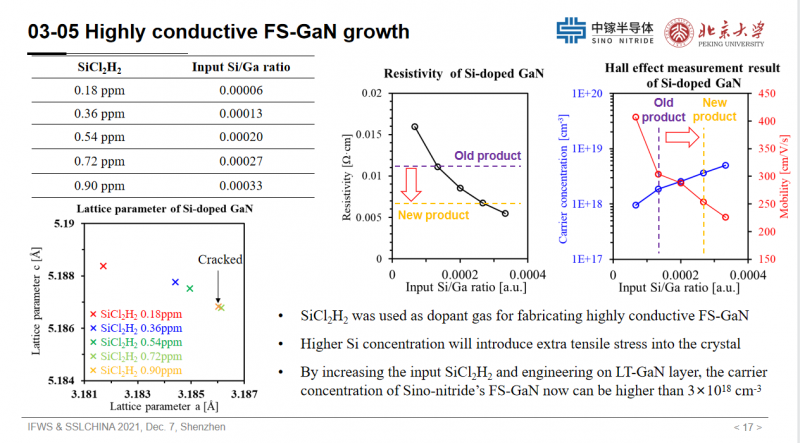

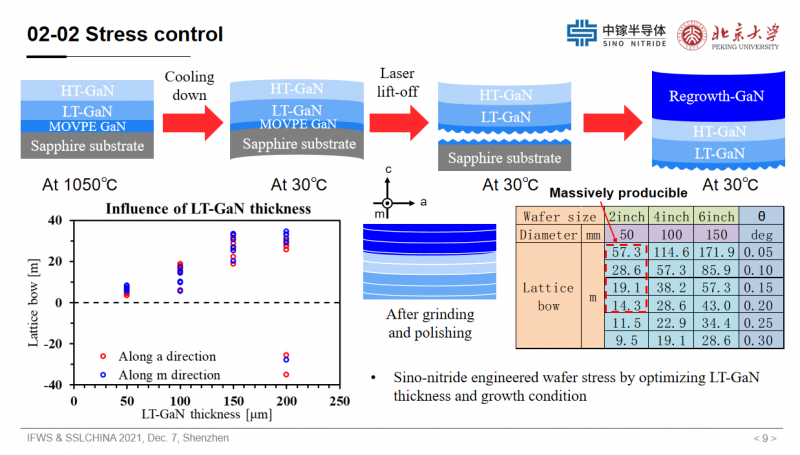
所有使用HVPE的 FS-GaN制造技術(shù)的有兩個(gè)關(guān)鍵問(wèn)題,一是如何控制生長(zhǎng)過(guò)程中的應(yīng)力以避免開(kāi)裂,二是如何從異物襯底上剝離GaN層。報(bào)告詳細(xì)介紹了通過(guò)碳摻雜實(shí)現(xiàn)半絕緣 GaN 生長(zhǎng)、碳摻雜 GaN 中的雜質(zhì)濃度、碳摻雜氮化鎵的電學(xué)特性、半絕緣FS-GaN參數(shù)選擇、高導(dǎo)電FS-GaN生長(zhǎng)等內(nèi)容。
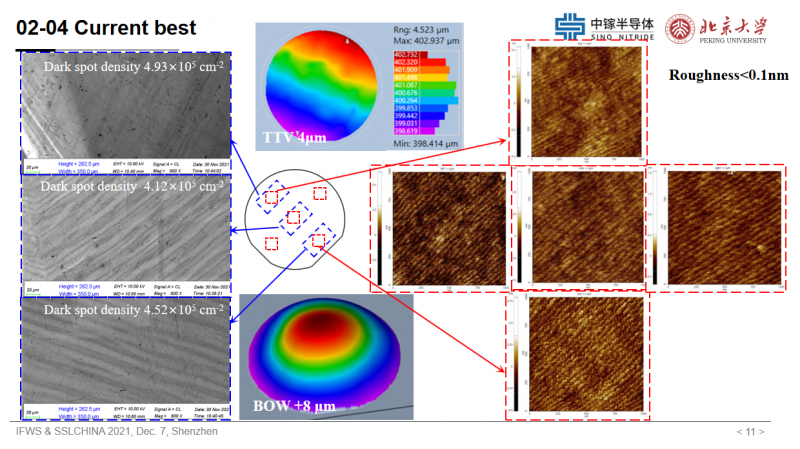
報(bào)告指出,具有較低位錯(cuò)密度的FS-GaN襯底將有助于改進(jìn)包括光電器件、垂直GaN功率器件和高頻器件在內(nèi)的所有GaN-on-FS-GaN器件。GaN LD和垂直功率器件(如 GaN PND)首選高導(dǎo)電性 FS-GaN,同時(shí) GaN-on-GaN HEMT需要具有高電阻率的半絕緣FS-GaN。
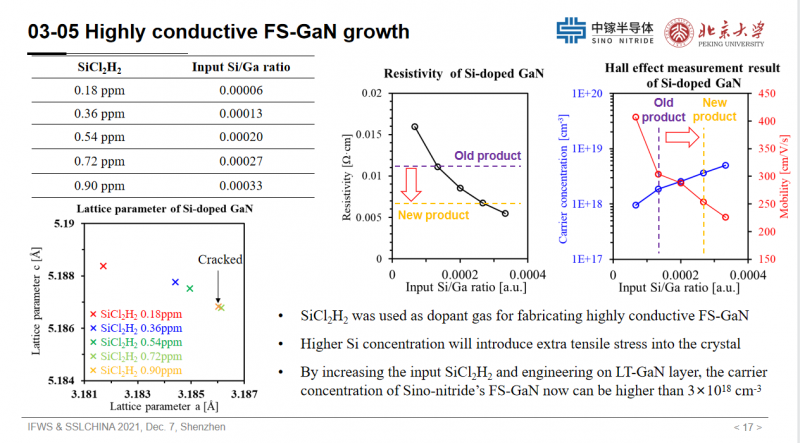
通過(guò)結(jié)合LT-GaN插入層和激光剝離技術(shù),Sino-nitride具有大規(guī)模生產(chǎn)FS-GaN襯底的能力。通過(guò)優(yōu)化LT-GaN層厚度和生長(zhǎng)條件,F(xiàn)S-GaN產(chǎn)品無(wú)法達(dá)到更好的切割角均勻度(<0.2)、更低的位錯(cuò)密度(>4×105 cm-2)和更好的表面狀態(tài)(RSM<0.1nm)。半絕緣 FS-GaN 襯底是用CH4 摻雜劑實(shí)現(xiàn)的,室溫電阻率超過(guò) 109 Ω·cm。通過(guò)應(yīng)力工程實(shí)現(xiàn)載流子濃度高于3×1018 cm-3的高導(dǎo)電FS-GaN襯底。
(內(nèi)容根據(jù)現(xiàn)場(chǎng)資料整理,如有出入敬請(qǐng)諒解)
