隨著國(guó)防軍工、計(jì)算機(jī)和汽車(chē)電子產(chǎn)業(yè)的發(fā)展,電子產(chǎn)品和系統(tǒng)要求實(shí)現(xiàn)功能強(qiáng)、性能優(yōu)、體積小、重量輕之特性,從當(dāng)前電子產(chǎn)品及芯片發(fā)展的技術(shù)領(lǐng)域來(lái)考慮,實(shí)現(xiàn)該功能的電子產(chǎn)品有兩種方式:其一,從芯片設(shè)計(jì)角度出發(fā),依賴(lài)于 SoC 片上系統(tǒng)芯片設(shè)計(jì)及制造技術(shù)的發(fā)展和推進(jìn);其二,從芯片封裝技術(shù)的角度考慮,依賴(lài)于近年來(lái)逐步發(fā)展和成熟起來(lái)的先進(jìn)封裝技術(shù)的支持。
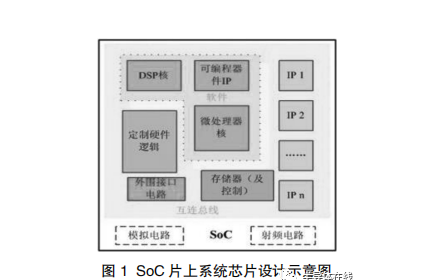
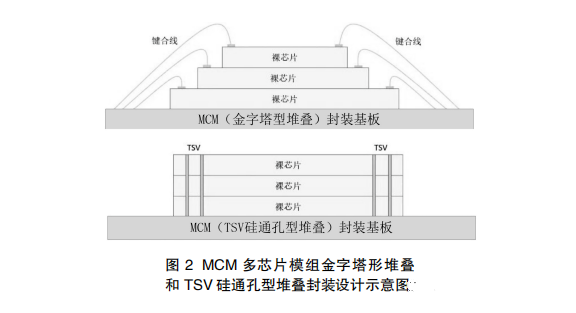
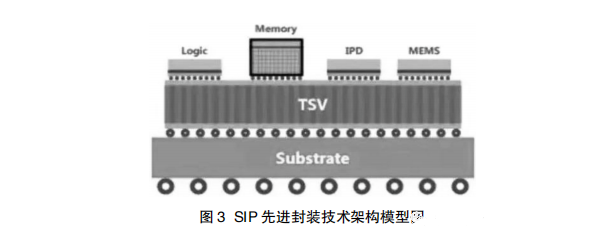
SoC(System on Chip)片上系統(tǒng)是芯片研發(fā)人員研究的主方向。它是將多個(gè)功能模塊進(jìn)行片上系統(tǒng)設(shè)計(jì),進(jìn)而形成一個(gè)單芯片電子系統(tǒng),實(shí)現(xiàn)電子產(chǎn)品小型化、多功能、高可靠的特征需求,是芯片向更高層次發(fā)展的終極目標(biāo);但是,SoC 片上系統(tǒng)需要多個(gè)功能模塊工藝集成,同時(shí)涉及各功能模塊電路的信號(hào)傳輸和處理,技術(shù)要求高,研發(fā)周期長(zhǎng),開(kāi)發(fā)成本高,無(wú)法滿(mǎn)足電子產(chǎn)品升級(jí)換代的快速更新?;谝陨袭a(chǎn)品需求,在混合集成電路 HIC(Hybrid integrated circuit)封裝技術(shù)基礎(chǔ)上,MCM(Multi-Chip Module)及 SIP(System in package)等微電子封裝技術(shù)逐漸在此方向上獲得突破,在犧牲部分面積等指標(biāo)的情況下,形成單一的封裝“芯片”,并且可快速實(shí)現(xiàn)相同功能的芯片量產(chǎn),推動(dòng)產(chǎn)品快速上市。
本文將介紹 SoC 片上系統(tǒng)的優(yōu)勢(shì)和產(chǎn)品快速更新需求的矛盾,為解決此矛盾,從封裝技術(shù)角度出發(fā),給出微電子封裝技術(shù)發(fā)展的 3 個(gè)關(guān)鍵環(huán)節(jié),即HIC、MCM 及 SIP,介紹了其各自封裝技術(shù)的優(yōu)缺點(diǎn),闡釋了 HIC、MCM 及 SIP 的相互關(guān)系,最終分析形成一套基本滿(mǎn)足 SOC 片上系統(tǒng)功能且可快速開(kāi)發(fā)組裝形成批量產(chǎn)能的 SIP 封裝技術(shù),快速實(shí)現(xiàn)電子產(chǎn)品整機(jī)或系統(tǒng)的芯片級(jí)更新需求。
1 SoC 片上系統(tǒng)分析
SoC 即系統(tǒng)級(jí)芯片,從狹義的角度講,SoC 是信息系統(tǒng)核心的芯片集成,是將系統(tǒng)關(guān)鍵部件集成在一塊芯片上;從廣義的角度講,SoC 是一個(gè)微小型系統(tǒng)。與一般芯片定義相比,SoC 更強(qiáng)調(diào)的是一個(gè)系統(tǒng)整體,即由多個(gè)具有特定功能的集成電路組合在一個(gè)芯片上,對(duì)所有或部分必要的電子電路進(jìn)行整體設(shè)計(jì)和加工的技術(shù),最終形成包含完整的軟硬件的系統(tǒng)或產(chǎn)品。圖 1 所示為 SoC 片上系統(tǒng)芯片在同一硅片上的設(shè)計(jì)示意圖。
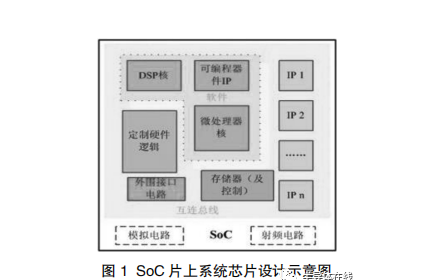
SoC 片上系統(tǒng)芯片在諸多方面有其優(yōu)勢(shì),主要表現(xiàn):
其一,重量輕,體積小,便攜性能強(qiáng)。由于多個(gè)功能模塊 IC 整合為一顆 SoC 后,可有效縮減封裝尺寸,應(yīng)用時(shí)可有效縮小占用 PCB 的面積;
其二,功耗低,運(yùn)行速度快,低延時(shí)性能強(qiáng)。多個(gè)功能模塊信號(hào)實(shí)現(xiàn)內(nèi)部傳遞,距離大大縮短,不僅降低功耗,同時(shí)信號(hào)傳輸效率提升,從而使產(chǎn)品性能有所提高;
其三,在相同面積硅片上,SoC 具有高效的系統(tǒng)集成能力,豐富系統(tǒng)功能;
其四,SoC 片上系統(tǒng)芯片被整合到一塊硅片上,具有相同的熱效應(yīng),電磁兼容特性亦得到極大提高,芯片整體性能得到提升;
其五,大批量生產(chǎn)時(shí)能提供所實(shí)現(xiàn)功能的最低成本。
由于 SoC 擁有空前的高效集成性能,且在功耗、可靠性、與適用范圍各方面都有明顯的優(yōu)勢(shì),目前在性能和功耗敏感的終端芯片領(lǐng)域,SoC 已占據(jù)主導(dǎo)地位,而且其應(yīng)用領(lǐng)域正在擴(kuò)展,它是替代分散式多模塊集成電路的主要解決方案。盡管如此,SoC 依然存在一些待解決的問(wèn)題:
其一,SoC 開(kāi)發(fā)實(shí)際上是 IP 模塊的組合,由于芯片結(jié)構(gòu)的復(fù)雜性逐步增強(qiáng),可能導(dǎo)致測(cè)試成本增加,測(cè)試周期大大延長(zhǎng),生產(chǎn)成品率下降,單個(gè)產(chǎn)品成本高;
其二,SoC 片上系統(tǒng)復(fù)雜性提升,因此設(shè)計(jì)錯(cuò)誤、產(chǎn)品延遲和芯片制造反復(fù)導(dǎo)致成本增加的風(fēng)險(xiǎn)很高,上市時(shí)間長(zhǎng);
其三,SoC 片上系統(tǒng)技術(shù)上把數(shù)字、模擬、RF、微波信號(hào)、MEMS 等集成在同一個(gè)芯片上的工藝兼容問(wèn)題。
SoC 片上系統(tǒng)芯片開(kāi)發(fā)遇到的相關(guān)問(wèn)題通過(guò)先進(jìn)封裝技術(shù)可以進(jìn)行較大程度的彌補(bǔ),即 MCM 封裝技術(shù)及 SIP 系統(tǒng)級(jí)封裝技術(shù)。
2 HIC、MCM 及 SIP 封裝技術(shù)分析
芯片封裝過(guò)程中,出現(xiàn)了 HIC、MCM 及 SIP,其最終目標(biāo)為在適當(dāng)擴(kuò)展面積的基礎(chǔ)上,盡可能實(shí)現(xiàn)同等功能的 SoC 芯片功能,避免 SoC 芯片開(kāi)發(fā)的缺點(diǎn),快速形成產(chǎn)品。
2.1 HIC 封裝技術(shù)
HIC 即混合集成電路封裝。它是實(shí)現(xiàn)電子元件與器件集成化的重要形式和技術(shù)手段,其目的主要追求電路模塊化與電子元器件的集成化,HIC 封裝是推動(dòng) MCM 及 SIP 封裝技術(shù)的重要基礎(chǔ)。依據(jù)基板種類(lèi)及制造工藝的不同,HIC 混合集成電路分薄膜HIC 和厚膜 HIC。
(1)薄膜 HIC。其是將整個(gè)電路的晶體管、二極管、電阻、電容和電感等元件以及金屬導(dǎo)線,通過(guò)真空蒸發(fā)、濺射、電鍍、薄膜刻蝕等工藝,在絕緣基板或者表面帶有絕緣層的硅片和金屬基板上制作厚度在1um 左右薄膜導(dǎo)線和器件,形成薄膜 HIC。對(duì)于薄膜集成電路中尚未達(dá)到全膜化水平的有源器件芯片、功率電阻、大容量電容器和電感等元件,需采用熱壓焊接、超聲焊接、引線鍵合或凸點(diǎn)倒樁焊接等方式,將其貼裝在薄膜基板上,形成薄膜 HIC。
(2)厚膜 HIC。其是在陶瓷等絕緣基片材料上,通過(guò)絲網(wǎng)印刷、燒結(jié)以及噴涂等技術(shù)制作無(wú)源元件、導(dǎo)線和焊盤(pán),采用類(lèi)似 SMT 工藝組裝二極管、晶體管、或半導(dǎo)體集成電路芯片,構(gòu)成具有一定功能的電路,就是厚膜 HIC。通常認(rèn)為厚膜 HIC 工藝簡(jiǎn)便、成本低廉、能耐較大的功率,但它制作的元件種類(lèi)和數(shù)值范圍有一定限制,厚度通常為幾微米至幾十微米。厚膜電路的優(yōu)勢(shì)在于性能可靠,設(shè)計(jì)靈活,投資小,成本低,多應(yīng)用于電壓高、電流大、大功率的場(chǎng)合。
2.2 MCM 封裝技術(shù)
MCM 即多芯片模組。它是將 2 個(gè)或 2 個(gè)以上的大規(guī)模集成電路裸芯片和部分微型元器件電連接于同一塊共用的高密度互連基板(陶瓷、硅、金屬基板)上,并封裝到同一外殼內(nèi)所構(gòu)成的具有一定部件或系統(tǒng)功能的高密度微電子組件,圖 2 所示為 MCM多芯片模組金字塔形堆疊和 TSV (Through Silicon Via,硅通孔)堆疊封裝技術(shù)設(shè)計(jì)示意圖。
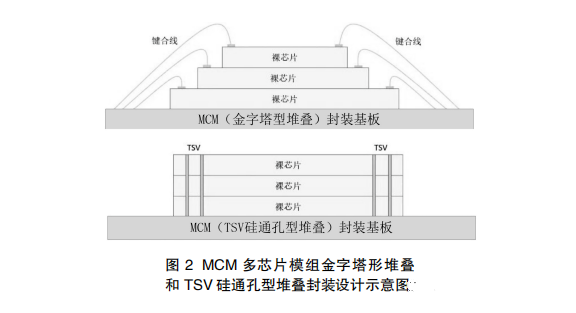
與傳統(tǒng)的 HIC 混合集成電路相比,其特點(diǎn)是:
1. MCM 采用高密度多層布線基板,功能模塊采用大規(guī)模和超大規(guī)模的裸芯片,有更高的組裝密度,不僅使得電路尺寸減小,重量減輕,焊點(diǎn)數(shù)量減少,而且互連線長(zhǎng)度縮短,信號(hào)延時(shí)大大減小。
2. MCM 通常是一個(gè)系統(tǒng)或者子系統(tǒng),外形上MCM 比普通的 HIC 具有更多的 I\O 引腳;
3. MCM 組裝的芯片規(guī)模傾向于大規(guī)模和超大規(guī)模集成電路,而 HIC 封裝芯片規(guī)模通常為中小規(guī)模集成電路;
4. MCM 技術(shù)上追求的是高速度、高性能、多功能、高可靠,而非一般 HIC 技術(shù)所追求的縮小體積、減輕重量;
應(yīng)該看到,MCM 是以 HIC 封裝技術(shù)為基礎(chǔ),形成更高級(jí)、更復(fù)雜的混合集成電路,它是實(shí)現(xiàn)電路集成的重要封裝技術(shù)模式。其主要特征:一是 MCM 系統(tǒng)主要由芯片組成,集成無(wú)源元件形式和數(shù)量較少,多用于數(shù)字電路;二是它是 SIP 封裝技術(shù)的特定形式。
2.3 SIP 先進(jìn)封裝技術(shù)
SIP 即系統(tǒng)級(jí)封裝,其定義首先強(qiáng)調(diào)的是系統(tǒng),其次是封裝。SIP 是在 HIC 和 MCM 封裝技術(shù)基礎(chǔ)上,將多種功能芯片和附屬無(wú)源器件在三維空間內(nèi)組裝到大小只有封裝尺寸的體積內(nèi),如處理器、存儲(chǔ)器、傳感器、射頻收發(fā)器件等功能模塊芯片混合搭載于同一個(gè)封裝體之內(nèi),實(shí)現(xiàn)一定系統(tǒng)功能的單個(gè)標(biāo)準(zhǔn)封裝件,形成一個(gè)系統(tǒng)或者子系統(tǒng)封裝技術(shù),圖 3所示為 SIP 封裝技術(shù)的架構(gòu)模型圖。
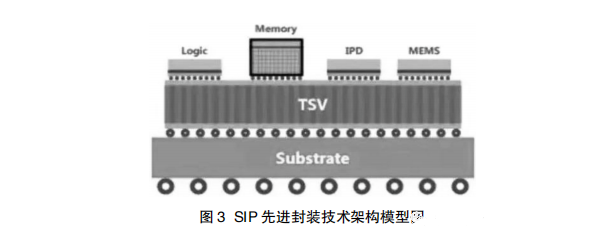
2.3.1 SIP 封裝技術(shù)工藝與 SoC 片上系統(tǒng)比較優(yōu)勢(shì)
從封裝技術(shù)角度考慮,SIP 封裝技術(shù)是最受關(guān)注的系統(tǒng)集成化技術(shù),相比于 SoC 片上系統(tǒng)芯片,SIP 具有如下優(yōu)勢(shì):
其一,功能芯片采用現(xiàn)有成熟設(shè)計(jì),大幅度降低開(kāi)發(fā)成本,縮短產(chǎn)品研發(fā)周期,使得產(chǎn)品迅速占領(lǐng)市場(chǎng);
其二,由于 CSP、BGA 技術(shù)成熟,大多數(shù)元件在封裝前已經(jīng)過(guò)測(cè)試,組裝后的成品率高,價(jià)格低;
其三,對(duì)于 SoC,所有器件都在同一工藝和材料下制造,互連線復(fù)雜,只能靠增加金屬層數(shù)來(lái)實(shí)現(xiàn)互連,而對(duì)于 SIP,多層基板技術(shù)較成熟,器件間的互連大部分由基板承擔(dān)。
2.3.2 SIP 與 HIC、MCM 封裝技術(shù)比較
SIP 是 HIC 和 MCM 基礎(chǔ)上發(fā)展起來(lái)的封裝技術(shù)工藝,相比于 HIC 和 MCM 封裝芯片,SIP 具有如下優(yōu)勢(shì):
其一,封裝設(shè)計(jì)重在系統(tǒng),其次在封裝,封裝規(guī)模遠(yuǎn)大于 MCM 和 HIC;
其二,SIP 封裝可在封裝基板上對(duì)多個(gè)不同功能的芯片采用凸點(diǎn)倒裝、SMT 及線邦工藝進(jìn)行三維堆疊封裝,封裝基板層數(shù)更多,線徑更細(xì);
其三,SIP 封裝所用 IC 大多數(shù)為裸芯片,亦可以采用封裝芯片,無(wú)源器件可以采用膜式器件,亦可以貼裝器件;
其四,將不同制造工藝的模擬、數(shù)字、射頻、MCU、FPGA、MEMS 等功能芯片在同一個(gè)封裝體內(nèi)實(shí)現(xiàn)系統(tǒng)功能。
2.3.3 SIP 封裝技術(shù)工藝難點(diǎn)
SIP 先進(jìn)封裝技術(shù)應(yīng)用并非無(wú)任何障礙,主要困難表現(xiàn)如下:
其一,合適的裸芯片資源少量購(gòu)買(mǎi)較困難:為提高封裝密度,SIP 封裝內(nèi)部的功能芯片多為裸 die,試驗(yàn)過(guò)程中少量需求裸 die 很難采購(gòu);
其二,系統(tǒng)模塊開(kāi)發(fā)搭建人力資源:SIP 封裝是將單片機(jī)、射頻芯片、傳感器等芯片組成一個(gè)系統(tǒng),因此 SIP 封裝系統(tǒng)開(kāi)發(fā)及功能芯片搭建需要有一定基礎(chǔ)的 SIP 封裝經(jīng)驗(yàn);
其三,封裝廠資源導(dǎo)致的導(dǎo)入困難:由于國(guó)內(nèi)絕大多數(shù)封裝廠設(shè)計(jì)資源有限且封裝排片任務(wù)較重,導(dǎo)致非量產(chǎn)項(xiàng)目或者中小規(guī)模用戶(hù)得不到足夠的SIP 封裝專(zhuān)業(yè)設(shè)計(jì)的支持,通常需要有專(zhuān)業(yè)的 SIP 公司配合執(zhí)行。
3 HIC、MCM、SIP 封裝技術(shù)之間的相互關(guān)系
毫無(wú)疑問(wèn),IC 封裝技術(shù)的發(fā)展是不斷進(jìn)步和創(chuàng)新的過(guò)程,是對(duì)原有技術(shù)的整理、迭代、創(chuàng)新和再發(fā)展,HIC、MCM 及 SIP 封裝技術(shù)即是如此。
如 HIC 在各種基板上安裝的主要是無(wú)源元件,半導(dǎo)體器件占比非常少,使用 HIC 封裝技術(shù)的半導(dǎo)體器件通常使用封裝后的器件,通常認(rèn)為 HIC 封裝技術(shù)制成電路相對(duì)簡(jiǎn)單。
又如 MCM 封裝技術(shù)是在各種高密度多層基板上安裝,主體是半導(dǎo)體裸芯片,制成部件的電路一般較為復(fù)雜,因此 MCM 封裝技術(shù)是 HIC 混合集成電路技術(shù)的延伸,是一種高級(jí)混合集成技術(shù)。
而 SIP 封裝技術(shù)其市場(chǎng)規(guī)模和增長(zhǎng)空間都較MCM 大,當(dāng)然 SIP 是 MCM 封裝技術(shù)進(jìn)一步發(fā)展的產(chǎn)物,其核心是各模塊芯片和元器件在不同工作頻段的高密度組裝和互連。MCM 多芯片模組主要是通過(guò)將各種裸芯片堆疊連接,元器件較少,通常為數(shù)字芯片、存儲(chǔ)器芯片為主,而 SIP 封裝可安裝不同工藝、不同功能的芯片,芯片之間可進(jìn)行信號(hào)的存取和交換,從而完成一個(gè)系統(tǒng)目標(biāo)產(chǎn)品的全部互連以及功能和性能。
4 總結(jié)
對(duì)于系統(tǒng)級(jí)設(shè)計(jì),組成系統(tǒng)的各個(gè)模塊 IP 庫(kù)開(kāi)發(fā)正常的條件下,優(yōu)先使用 SoC 片上系統(tǒng)設(shè)計(jì)方案,其基本設(shè)計(jì)思想就是實(shí)現(xiàn)全系統(tǒng)的固件集成,也是芯片發(fā)展的終極目標(biāo)。
如果組成系統(tǒng)的各個(gè)模塊由多家供應(yīng)商提供,最有效的可最大程度實(shí)現(xiàn) SoC 片上系統(tǒng)功能的捷徑是采用 SIP 先進(jìn)封裝技術(shù),即由不同工藝制程生產(chǎn)的、來(lái)自不同廠家提供的多個(gè)功能模塊芯片及無(wú)源元件,通過(guò) SIP 先進(jìn)封裝技術(shù),安裝到一個(gè)小型封裝體內(nèi)實(shí)現(xiàn)“芯片”功能。
實(shí)際上,SOC 片上系統(tǒng)設(shè)計(jì)和 SIP 系統(tǒng)級(jí)封裝,兩者均以系統(tǒng)芯片設(shè)計(jì)為目標(biāo),可實(shí)現(xiàn)電子產(chǎn)品小、輕、薄需求,且其功能性能可靠。SoC 是從設(shè)計(jì)出發(fā),是將系統(tǒng)所需的組件高度集成到一塊芯片上,SIP是從封裝的立場(chǎng)出發(fā),將不同的芯片進(jìn)行疊加的封裝方式,將有源無(wú)源器件封裝在一起,實(shí)現(xiàn)一定功能的單個(gè)標(biāo)準(zhǔn)封裝件。
來(lái)源:中國(guó)集成電路
作者:楊躍勝、傅霖煌(深圳市遠(yuǎn)望谷信息技術(shù)股份有限公司)
