據(jù)semiwiki報(bào)道,預(yù)計(jì) 3nm 節(jié)點(diǎn)的金屬間距約為 22nm。這對(duì) EUV 光刻技術(shù)的使用提出了一些新的挑戰(zhàn)。這些挑戰(zhàn)針對(duì)0.33NA 與 0.55NA 系統(tǒng)的一些挑戰(zhàn)是不同的。
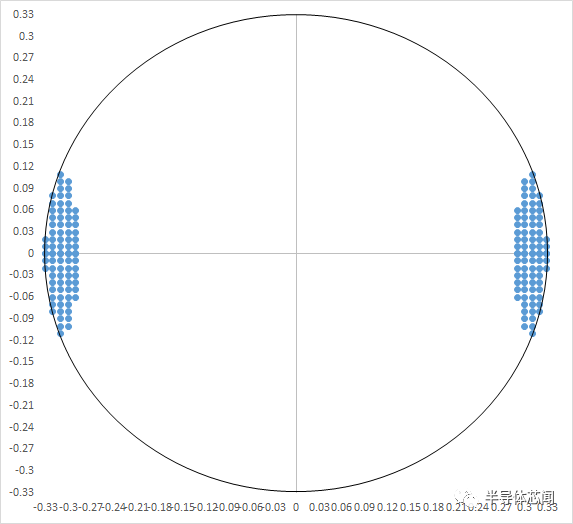

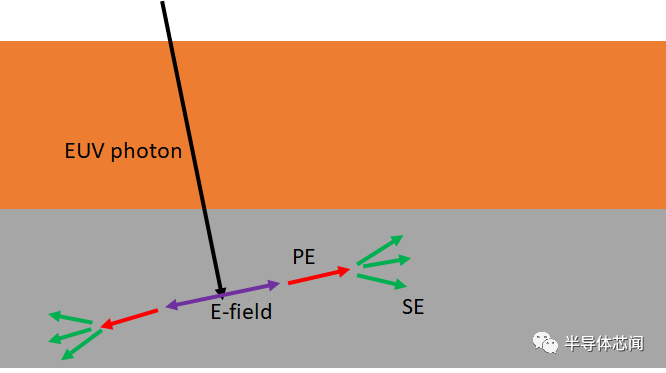
對(duì)于 0.33 NA 系統(tǒng),22 nm 間距只能通過(guò)填充 4% pupil的illumination來(lái)支持,遠(yuǎn)低于標(biāo)稱吞吐量的 20% 下限(圖 1)。
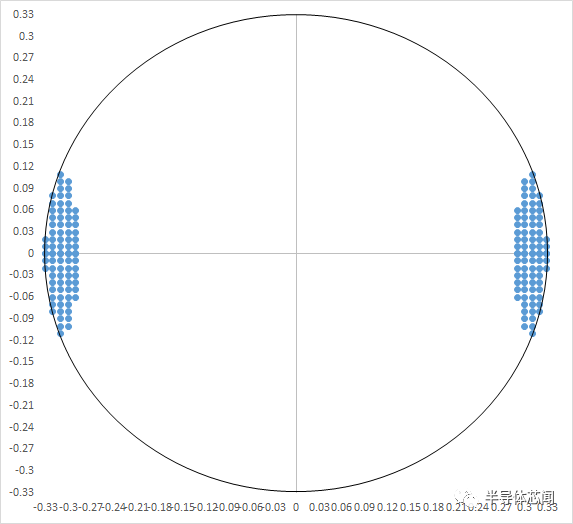
圖 1. 22 nm 間距的允許illumination僅填充 0.33 NA pupil的 4%。
這意味著吞吐量可能會(huì)大大低于 100 wph @40 mJ/cm2 ,因?yàn)榇蟛糠止庠诘竭_(dá)掩模之前就被聚光鏡吸收了。例如,額外的光吸收本身就是組件加熱的一個(gè)問(wèn)題。因此,即使使用 EUV,44 nm 間距的圖案化也可以加倍以實(shí)現(xiàn) 22 nm 間距。
對(duì)于 0.55 NA 系統(tǒng),希望單次曝光可以同時(shí)圖案化水平和垂直 22nm 間距特征,pupil填充率超過(guò) 20%。然而,一些 2D 特征,例如 31 nm 間距交錯(cuò)觸點(diǎn)/通孔(圖 2),由于遮擋消除了最低衍射級(jí),因此無(wú)法方便地與這種曝光兼容。

圖 2. quasar illumination形狀需要滿足布局中 22 nm 的水平和垂直間距,但 31 nm 交錯(cuò)特征將進(jìn)一步限制illumination,低于pupil的 20%。
22 nm 節(jié)距quasar illumination的較小部分使得最低衍射級(jí)避免了遮擋可以安全使用,但填充的pupil不到 20%,這再次意味著額外的聚光鏡吸收和減少的吞吐量,如 0.33 NA 的情況。這種圖案不兼容性在現(xiàn)有的光刻系統(tǒng)中沒(méi)有出現(xiàn),因?yàn)樗鼈儧](méi)有任何遮蔽。但對(duì)于 0.55 NA EUV 系統(tǒng),如果這種交錯(cuò)的 2D 圖案需要與水平和垂直特征保持一致,則必須單獨(dú)曝光。
由于焦深減小,22 nm(或更?。╅g距 0.55 NA 單次曝光將需要使用超?。?le;20 nm)光刻膠。對(duì)于 20 nm 的光刻膠厚度,化學(xué)放大光刻膠 (5/um) 的吸收率將下降到 10%,金屬氧化物光刻膠 (20/um) 的吸收率將下降到三分之一,這意味著大部分能量將被光刻膠下方吸收 。這種能量的有限部分可以作為返回的光電子和二次電子返回到光刻膠,因?yàn)檫@些電子實(shí)際上優(yōu)先平行于抗蝕劑/底層界面發(fā)射(圖3)。
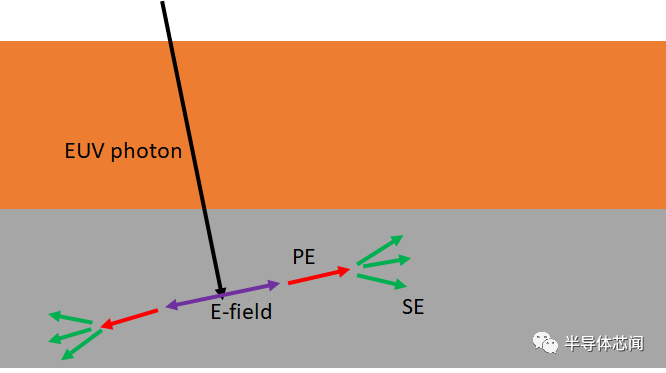
圖 3. 在光刻膠厚度低于 30 nm 時(shí),大部分 EUV 光子(黑色)在抗蝕劑膜(橙色)下方被吸收,光電子(紅色)和二次電子(綠色)大部分平行于界面發(fā)射。光電子發(fā)射優(yōu)先沿電場(chǎng)方向(紫色)定向,隨后的二次電子發(fā)射優(yōu)先保持光電子方向。
因此,隨著光刻膠變薄,EUV 曝光的能量效率會(huì)降低。此外,減少的吸收加劇了隨機(jī)效應(yīng)。因此,即使在 3nm 的 EUV 中,多重圖案也有望得到顯著的應(yīng)用。因此,應(yīng)重新考慮 EUV 使用對(duì)環(huán)境的影響。
原文鏈接:
https://semiwiki.com/lithography/316218-euvs-pupil-fill-and-resist-limitations-at-3nm/
(來(lái)源:半導(dǎo)體芯聞)
(來(lái)源:半導(dǎo)體芯聞)
